| Citation: |
Zhen Yang, Jinyan Wang, Zhe Xu, Xiaoping Li, Bo Zhang, Maojun Wang, Min Yu, Jincheng Zhang, Xiaohua Ma, Yongbing Li. Analysis of AlGaN/GaN high electron mobility transistors failure mechanism under semi-on DC stress[J]. Journal of Semiconductors, 2014, 35(1): 014007. doi: 10.1088/1674-4926/35/1/014007
****
Z Yang, J Y Wang, Z Xu, X P Li, B Zhang, M J Wang, M Yu, J C Zhang, X H Ma, Y B Li. Analysis of AlGaN/GaN high electron mobility transistors failure mechanism under semi-on DC stress[J]. J. Semicond., 2014, 35(1): 014007. doi: 10.1088/1674-4926/35/1/014007.
|
Analysis of AlGaN/GaN high electron mobility transistors failure mechanism under semi-on DC stress
DOI: 10.1088/1674-4926/35/1/014007
More Information
-
Abstract
Semi-on DC stress experiments were conducted on AlGaN/GaN high electron mobility transistors (HEMTs) to find the degradation mechanisms during stress. A positive shift in threshold voltage (VT) and an increase in drain series resistance (RD) were observed after semi-on DC stress on the tested HEMTs. It was found that there exists a close correlation between the degree of drain current degradation and the variation in VT and RD. Our analysis shows that the variation in VT is the main factor leading to the degradation of saturation drain current (IDS), while the increase in RD results in the initial degradation of IDS in linear region in the initial several hours stress time and then the degradation of VT plays more important role. Based on brief analysis, the electron trapping effect induced by gate leakage and the hot electron effect are ascribed to the degradation of drain current during semi-on DC stress. We suggest that electrons in the gate current captured by the traps in the AlGaN layer under the gate metal result in the positive shift in VT and the trapping effect in the gate-drain access region induced by the hot electron effect accounts for the increase in RD.-
Keywords:
- AlGaN/GaN HEMT,
- reliability,
- semi-on DC stress,
- hot electron effect
-
References
[1] Li Xianjie, Zeng Qingming, Zhou Zhou, et al. AlGaN/GaN high electron mobility transistors on sapphires with fmax of 100 GHz. Chinese Journal of Semiconductors, 2005, 26(11):2049 http://www.oalib.com/paper/1519658[2] Feng Zhen, Zhang Zhiguo, Wang Yong, et al. A recessed AlGaN/GaN HEMT with high output power in the X band. Journal of Semiconductors, 2008, 28(11):1773(in Chinese) http://www.jos.ac.cn/bdtxbcn/ch/reader/view_abstract_new.aspx?volume=28&start_page=1773[3] Joh J, del Alamo J A. RF power degradation of GaN high electron mobility transistors. IEEE IEDM Technical Digest, 2010:468 http://ieeexplore.ieee.org/abstract/document/5703397[4] Chini A, Lecce V D, Fantini F, et al. Analysis of GaN HEMT failure mechanisms during DC and large-signal RF operation. IEEE Trans Electron Devices, 2012, 59(5):1385 doi: 10.1109/TED.2012.2188636[5] Douglas E A, Chang C Y, Cheney D J, et al. AlGaN/GaN high electron mobility transistor degradation under on-and off-state stress. Microeletron Reliab, 2011, 51:207 doi: 10.1016/j.microrel.2010.09.024[6] Ronchi N, Zanon F, Stocco A, et al. Reliability analysis of AlGaN/GaN HEMT on SopSiC composite substrate under long-term DC-life test. Microeletron Reliab, 2009, 49:1207 doi: 10.1016/j.microrel.2009.07.018[7] Douglas E A, Chang C Y, Cheney D J, et al. AlGaN/GaN high electron mobility transistor degradation under on-and off-state stress. Microelectron Reliab, 2011, 51:207 doi: 10.1016/j.microrel.2010.09.024[8] Wang Chong, Zhang Jincheng, Hao Yue, et al. Degradation under high-field stress and effects of UV irradiation on AlGaN/GaN HEMTs. Chinese Journal of Semiconductors, 2006, 26(8):1436(in Chinese) http://en.cnki.com.cn/Article_en/CJFDTOTAL-BDTX200608021.htm[9] Meneghesso G, Verzellesi G, Danesin F, et al. Reliability of GaN high-electron-mobility transistors:state of the art and perspectives. IEEE Trans Device Mater Reliab, 2008, 8:332 doi: 10.1109/TDMR.2008.923743[10] Zanoni E, Meneghesso G, Verzellesi G, et al. A review of failure modes and mechanisms of GaN-based HEMTs. IEEE IEDM Technical Digest, 2007:381 http://ieeexplore.ieee.org/document/4418952/keywords[11] Meneghini M, Stocco A, Ronchi N, et al. Extensive analysis of the luminescence properties of AlGaN/GaN high electron mobility transistors. Appl Phys Lett, 2010, 97:063508 doi: 10.1063/1.3479917[12] Meneghini M, Ronchi N, Stocco A, et al. Investigation of trapping and hot-electron effects in GaN HEMTs by means of a combined electrooptical method. IEEE Trans Electron Devices, 1996, 43(8):1304 doi: 10.1109/16.506784[13] Greenberg D R, del Alamo J A. Nonlinear source and drain resistance in recessed-gate heterostructure field-effect transistors. IEEE Trans Electron Devices, 2011, 58(9):2996 doi: 10.1109/TED.2011.2160547[14] Ortiz-Conde A, Sanchez F J G, Liou J J, et al. A review of recent MOSFET threshold voltage extraction methods. Microelectron Reliab, 2002, 42:583 doi: 10.1016/S0026-2714(02)00027-6 -
Proportional views





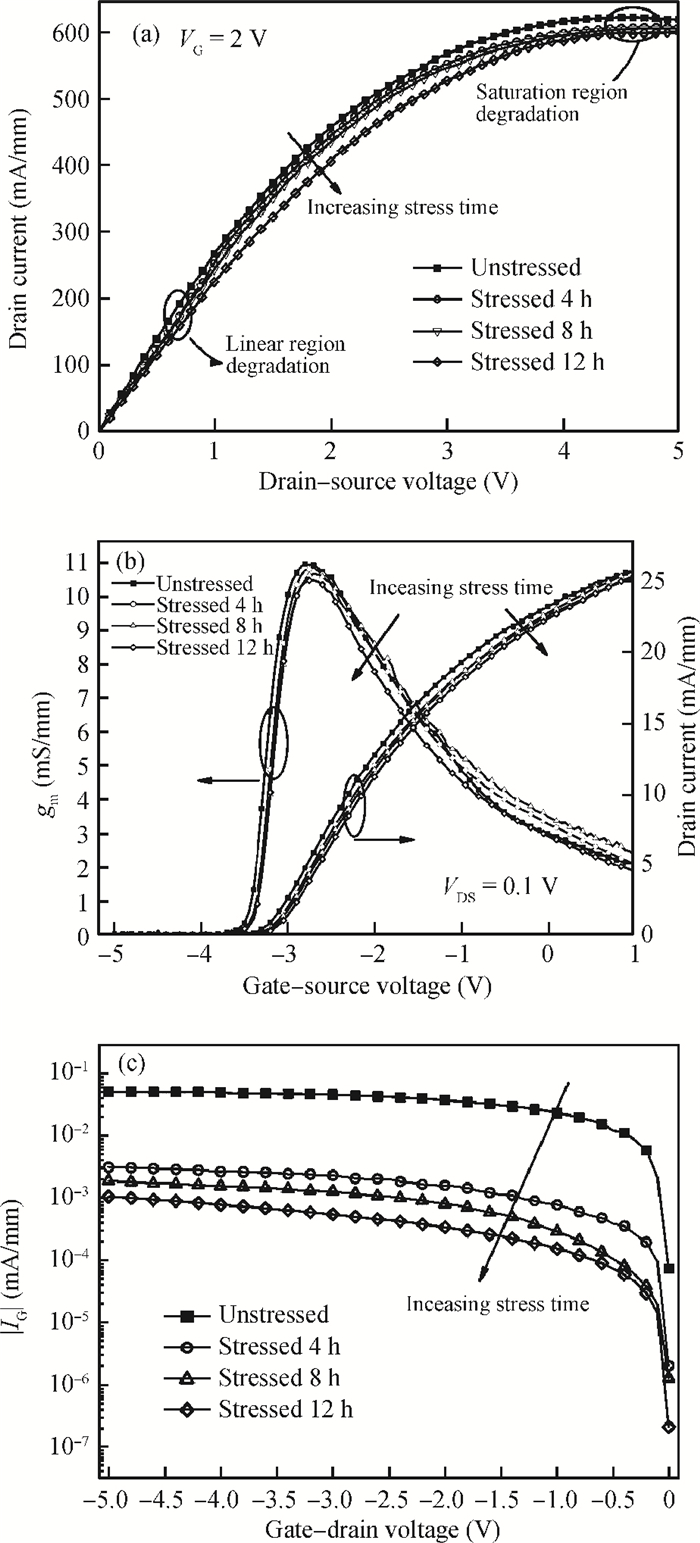
 DownLoad:
DownLoad: