| Citation: |
Ruichao Tian, Xiaorong Luo, Kun Zhou, Qing Xu, Jie Wei, Bo Zhang, Zhaoji Li. A novel high figure-of-merit SOI SJ LDMOS with ultra-strong charge accumulation effect[J]. Journal of Semiconductors, 2015, 36(3): 034007. doi: 10.1088/1674-4926/36/3/034007
****
R C Tian, X R Luo, K Zhou, Q Xu, J Wei, B Zhang, Z J Li. A novel high figure-of-merit SOI SJ LDMOS with ultra-strong charge accumulation effect[J]. J. Semicond., 2015, 36(3): 034007. doi: 10.1088/1674-4926/36/3/034007.
|
A novel high figure-of-merit SOI SJ LDMOS with ultra-strong charge accumulation effect
DOI: 10.1088/1674-4926/36/3/034007
More Information
-
Abstract
A novel silicon-on-insulator (SOI) super-junction (SJ) LDMOS with an ultra-strong charge accumulation effect is proposed. It has two key features: an assisted-accumulation trench-type extending gate (TEG) with a high-k (HK) dielectric and a step-doped N pillar (TEG-SD SJ LDMOS). In the on-state, electrons accumulate at the sidewall of the HK dielectric from the source to the drain by the TEG. Furthermore, the high permittivity of the HK dielectric leads to an ultra-strong charge accumulation effect. As a result, an ultra-low resistance current path is formed. The specific on-resistance (Ron,sp) is thus greatly reduced and is independent of the drift doping concentration. In the off-state, the step-doped N pillar effectively suppresses the substrate-assisted depletion effect by charge compensation. Moreover, the reshape effect of the HK dielectric and the new electric field (E-field) peak introduced by the step-doped N pillar enhance the drift region E-field. Hence, the BV is improved. Simulation indicates that the TEG-SD SJ LDMOS achieves an extremely low Ron,sp of 1.06 mΩ · cm2 and a BV of 217 V. Compared with the conventional SJ LDMOS, the TEG-SD SJ LDMOS decreases the Ron,sp by 77.5% and increases the BV by 33%, exhibiting a high figure of merits (FOM = BV2/Ron,sp) of 44 MW/cm2. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] -
Proportional views





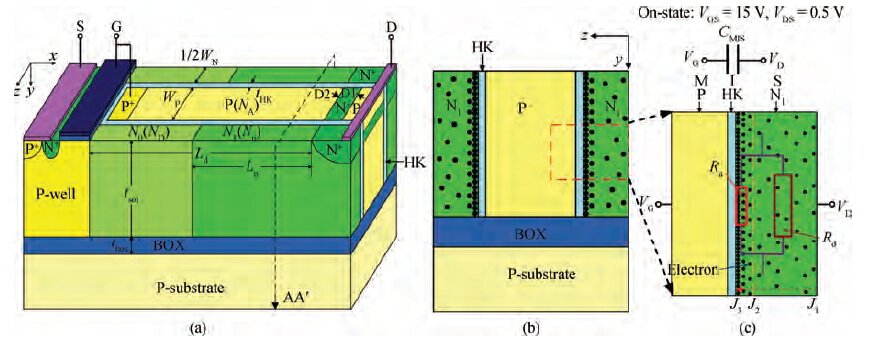
 DownLoad:
DownLoad: