| Citation: |
Xin Tan, Yuanjie Lü, Guodong Gu, Li Wang, Shaobo Dun, Xubo Song, Hongyu Guo, Jiayun Yin, Shujun Cai, Zhihong Feng. High performance AlGaN/GaN HEMTs with AlN/SiNx passivation[J]. Journal of Semiconductors, 2015, 36(7): 074008. doi: 10.1088/1674-4926/36/7/074008
****
X Tan, Y Lü, G D Gu, L Wang, S B Dun, X B Song, H Y Guo, J Y Yin, S J Cai, Z H Feng. High performance AlGaN/GaN HEMTs with AlN/SiNx passivation[J]. J. Semicond., 2015, 36(7): 074008. doi: 10.1088/1674-4926/36/7/074008.
|
High performance AlGaN/GaN HEMTs with AlN/SiNx passivation
DOI: 10.1088/1674-4926/36/7/074008
More Information
-
Abstract
AlGaN/GaN high electron-mobility transistors (HEMTs) with 5 nm AlN passivation by plasma enhanced atomic layer deposition (PEALD) were fabricated, covered by 50 nm SiNx which was grown by plasma enhanced chemical vapor deposition (PECVD). With PEALD AlN passivation, current collapse was suppressed more effectively and the devices show better subthreshold characteristics. Moreover, the insertion of AlN increased the RF transconductance, which lead to a higher cut-off frequency. Temperature dependence of DC characteristics demonstrated that the degradations of drain current and maximum transconductance at elevated temperatures for the AlN/SiNx passivated devices were much smaller compared with the devices with SiNx passivation, indicating that PEALD AlN passivation can improve the high temperature operation of the AlGaN/GaN HEMTs. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] -
Proportional views





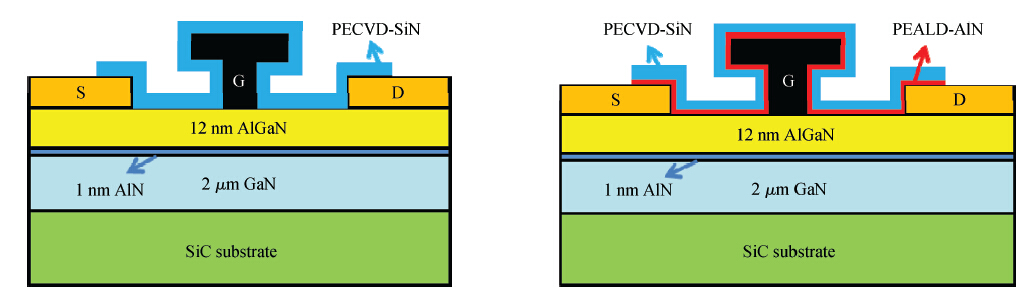
 DownLoad:
DownLoad: