| Citation: |
A. Divay, O. Latry, C. Duperrier, F. Temcamani. Ageing of GaN HEMT devices:which degradation indicators?[J]. Journal of Semiconductors, 2016, 37(1): 014001. doi: 10.1088/1674-4926/37/1/014001
****
A. Divay, O. Latry, C. Duperrier, F. Temcamani. Ageing of GaN HEMT devices:which degradation indicators?[J]. J. Semicond., 2016, 37(1): 014001. doi: 10.1088/1674-4926/37/1/014001.
|
Ageing of GaN HEMT devices:which degradation indicators?
DOI: 10.1088/1674-4926/37/1/014001
More Information
-
Abstract
A following of diverse degradation indicators during the ageing in operational conditions of AlGaN/GaN HEMTs (high electron mobility transistors) is proposed. Measurements of pulsed I-V, Schottky barrier height, RF output power and gate current versus output power during the early phase of the ageing test (2000 h on a 6000 h total) are presented. These preliminary results give insight on some of the principal degradation indicators that are interesting to follow during an ageing test close to operational conditions on such components.-
Keywords:
- GaN,
- HEMT,
- ageing tests,
- reliability
-
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] -
Proportional views





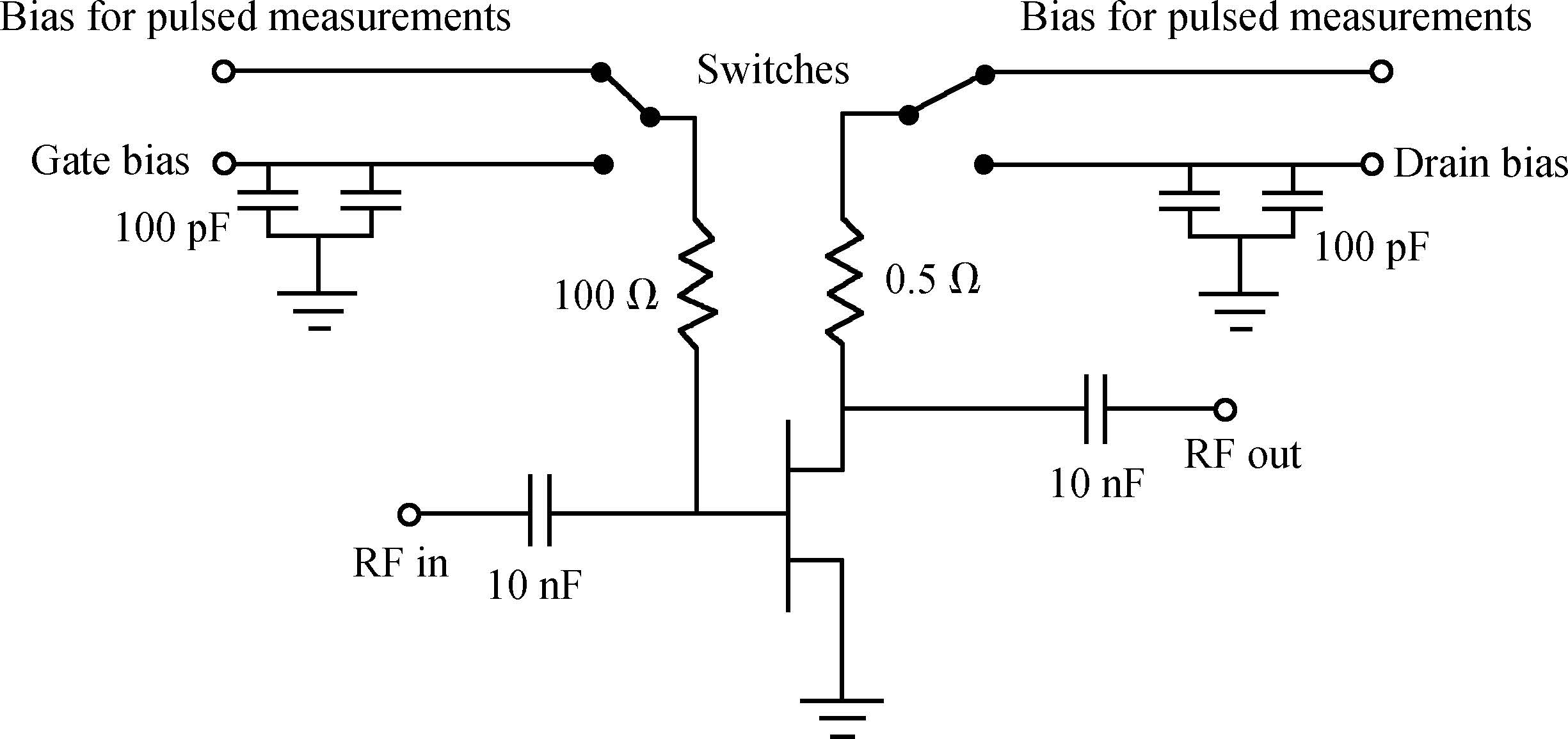
 DownLoad:
DownLoad: