| Citation: |
Jin Zhang, Yuling Liu, Chenqi Yan, Yangang He, Baohong Gao. Defectivity control of aluminum chemical mechanical planarization in replacement metal gate process of MOSFET[J]. Journal of Semiconductors, 2016, 37(4): 046001. doi: 10.1088/1674-4926/37/4/046001
****
J Zhang, Y L Liu, C Q Yan, Y G He, B H Gao. Defectivity control of aluminum chemical mechanical planarization in replacement metal gate process of MOSFET[J]. J. Semicond., 2016, 37(4): 046001. doi: 10.1088/1674-4926/37/4/046001.
|
Defectivity control of aluminum chemical mechanical planarization in replacement metal gate process of MOSFET
DOI: 10.1088/1674-4926/37/4/046001
More Information
-
Abstract
The replacement metal gate (RMG) defectivity performance control is very challenging in high-k metal gate (HKMG) chemical mechanical polishing (CMP). In this study, three major defect types, including fall-on particles, micro-scratch and corrosion have been investigated. The research studied the effects of polishing pad, pressure, rotating speed, flow rate and post-CMP cleaning on the three kinds of defect, which finally eliminated the defects and achieved good surface morphology. This study will provide an important reference value for the future research of aluminum metal gate CMP. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] -
Proportional views





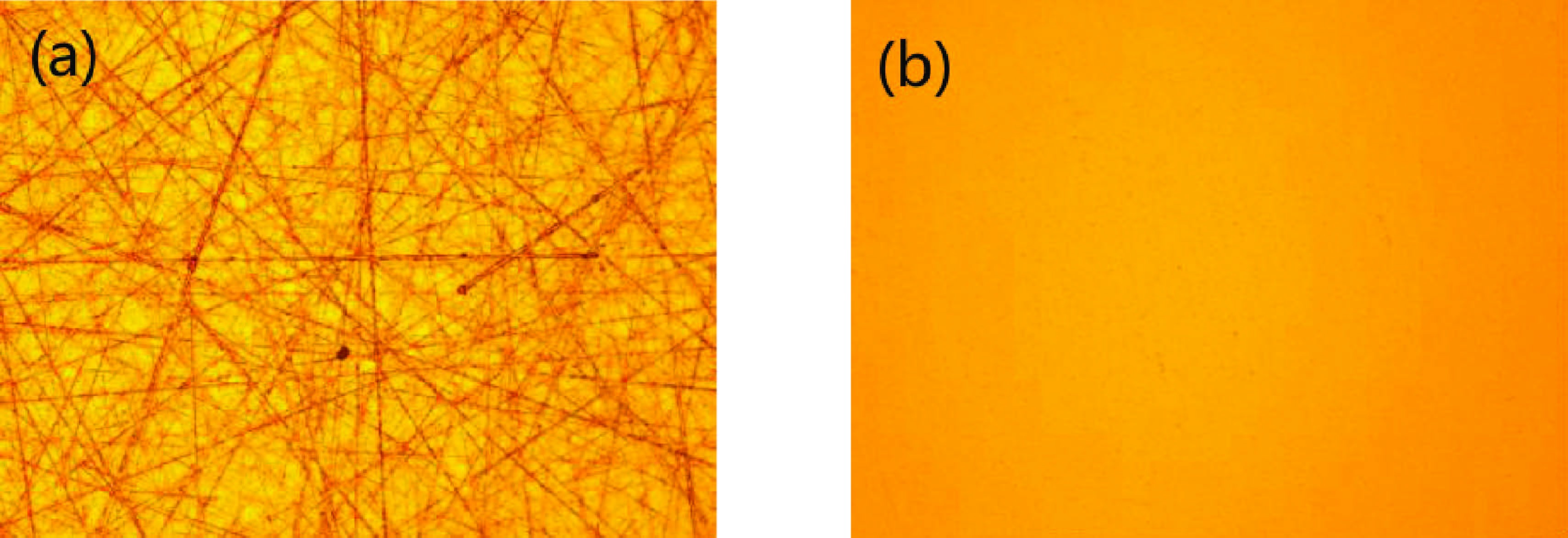
 DownLoad:
DownLoad: