| Citation: |
Xiaoli Tian, Weili Chu, Jiang Lu, Shuojin Lu, Qiaoqun Yu, Yangjun Zhu. A novel optimization design for 3.3 kV injection-enhanced gate transistor[J]. Journal of Semiconductors, 2014, 35(1): 014005. doi: 10.1088/1674-4926/35/1/014005
****
X L Tian, W L Chu, J Lu, S J Lu, Q Q Yu, Y J Zhu. A novel optimization design for 3.3 kV injection-enhanced gate transistor[J]. J. Semicond., 2014, 35(1): 014005. doi: 10.1088/1674-4926/35/1/014005.
|
A novel optimization design for 3.3 kV injection-enhanced gate transistor
DOI: 10.1088/1674-4926/35/1/014005
More Information
-
Abstract
This paper introduces a homemade injection-enhanced gate transistor (IEGT) with blocking voltage up to 3.7 kV. An advanced cell structure with dummy trench and a large cell pitch is adopted in the IEGT. The carrier concentration at the N-emitter side is increased by the larger cell pitch of the IEGT and it enhances the P-i-N effect within the device. The result shows that the IEGT has a remarkablely low on-state forward voltage drop (VCE(sat)) compared to traditional trench IGBT structures. However, too large cell pitch decreases the channel density of the trench IEGT and increases the voltage drop across the channel, finally it will increase the VCE(sat) of the IEGT. Therefore, the cell pitch selection is the key parameter consideration in the design of the IEGT. In this paper, a cell pitch selection method and the optimal value of 3.3 kV IEGT are presented by simulations and experimental results.-
Keywords:
- IEGT,
- dummy cell,
- 3.3kV,
- cell pitch
-
References
[1] Wu Yu, Lu Xiuhong, Kang Baowei, et al. A novel low power loss IGBT (LPL-IGBT) and its simulation. Chinese Journal of Semiconductors, 2001, 22(12):1565[2] Baliga J. The future of power semiconductor device technology. Proc IEEE, 2001, 89(6):822 doi: 10.1109/5.931471[3] Laska T, Pfirsch F, Hirler F, et al. 1200 V-trench-IGBT study with square short circuit SOA. Proc ISPSD, 1998:433[4] Omura I, Oguar T, Sugiyama K, et al. Carrier injection enhancement effect of high voltage MOS devices-device physics and design concept. Proc ISPSD, 1997: 217[5] Ogura T, Ninomuya H, Sugiyama K, et al. 4.5-kV injection-enhanced gate transistors (IEGTs) with high turn-off ruggedness. IEEE Trans Electron Devices, 2004, 51(4):636 doi: 10.1109/TED.2004.825111[6] Kitagawa M, Omura I, Hasegawa S, et al. A 4500 V injection enhanced insulated gate bipolar transistor (IEGT) operating in a mode similar to a thyristor. Electron Devices Meeting, 1993[7] Baliga J. Modern power devices. New York: J Wiley & Sons, 1987[8] Baliga B J. Fundamentals of power semiconductor devices. Springer, 2008[9] Laska T, Miinzer M, Pfirsch F, et al. The field stop IGBT (FS IGBT)-a new power device concept with a great improvement potential. Proc ISPSD, 2000: 355[10] Lu Jiang, Wang Lixin, Lu Shuojin, et al. Avalanche behavior of power MOSFETs under different temperature conditions. Journal of Semiconductors, 2011, 32(1):014001 doi: 10.1088/1674-4926/32/1/014001 -
Proportional views





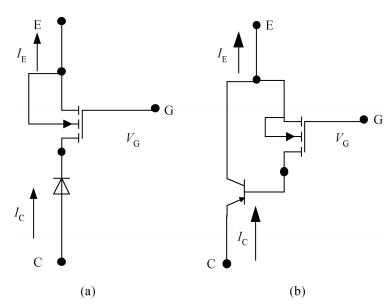
 DownLoad:
DownLoad: