| Citation: |
Yongbo Liu, Huilong Zhu, Yongkui Zhang, Xiaolei Wang, Weixing Huang, Chen Li, Xuezheng Ai, Qi Wang. Vertical nanowire/nanosheet FETs with a horizontal channel for threshold voltage modulation[J]. Journal of Semiconductors, 2022, 43(1): 014101. doi: 10.1088/1674-4926/43/1/014101
****
Y B Liu, H L Zhu, Y K Zhang, X L Wang, W X Huang, C Li, X Z Ai, Q Wang, Vertical nanowire/nanosheet FETs with a horizontal channel for threshold voltage modulation[J]. J. Semicond., 2022, 43(1): 014101. doi: 10.1088/1674-4926/43/1/014101.
|
Vertical nanowire/nanosheet FETs with a horizontal channel for threshold voltage modulation
DOI: 10.1088/1674-4926/43/1/014101
More Information
-
Abstract
A new type of vertical nanowire (VNW)/nanosheet (VNS) FETs combining a horizontal channel (HC) with bulk/back-gate electrode configuration, including Bulk-HC and FD-SOI-HC VNWFET, is proposed and investigated by TCAD simulation. Comparisons were carried out between conventional VNWFET and the proposed devices. FD-SOI-HC VNWFET exhibits better Ion/Ioff ratio and DIBL than Bulk-HC VNWFET. The impact of channel doping and geometric parameters on the electrical characteristic and body factor (γ) of the devices was investigated. Moreover, threshold voltage modulation by bulk/back-gate bias was implemented and a large γ is achieved for wide range Vth modulation. In addition, results of Ion enhancement and Ioff reduction indicate the proposed devices are promising candidates for performance and power optimization of NW/NS circuits by adopting dynamic threshold voltage management. The results of preliminary experimental data are discussed as well. -
References
[1] Hisamoto D, Lee W C, Kedzierski J, et al. FinFET – a self-aligned double-gate MOSFET scalable to 20 nm. IEEE Trans Electron Devices, 2000, 47, 2320 doi: 10.1109/16.887014[2] Loubet N, Hook T, Montanini P, et al. Stacked nanosheet gate-all-around transistor to enable scaling beyond FinFET. 2017 Symposium on VLSI Technology, 2017, 230 doi: 10.23919/VLSIT.2017.7998183[3] Ritzenthaler R, Mertens H, Pena V, et al. Vertically stacked gate-all-around Si nanowire CMOS transistors with reduced vertical nanowires separation, new work function metal gate solutions, and DC/AC performance optimization. 2018 IEEE International Electron Devices Meeting (IEDM), 2018, 21.5.1 doi: 10.1109/IEDM.2018.8614528[4] International Roadmap for Devices and Systems 2017 Edition More Moore, 2017. [Online]. Available: https://irds.ieee.org/editions/2017[5] Yakimets D, Eneman G, Schuddinck P, et al. Vertical GAAFETs for the ultimate CMOS scaling. IEEE Trans Electron Devices, 2015, 62, 1433 doi: 10.1109/TED.2015.2414924[6] Pan C Y, Raghavan P, Yakimets D, et al. Technology/system codesign and benchmarking for lateral and vertical GAA nanowire FETs at 5-nm technology node. IEEE Trans Electron Devices, 2015, 62, 3125 doi: 10.1109/TED.2015.2461457[7] Kwong D L, Li X, Sun Y, et al. Vertical silicon nanowire platform for low power electronics and clean energy applications. J Nanotechnol, 2012, 2012, 1 doi: 10.1155/2012/492121[8] Veloso A, Altamirano-Sanchez E, Brus S, et al. Vertical nanowire FET integration and device aspects. ECS Trans, 2016, 72, 31 doi: 10.1149/07204.0031ecst[9] Bohr M , Fellow I S . Silicon technology leadership for the mobility era. Intel Developer Forum, 2012[10] Choi Y K, Chang L, Ranade P, et al. FinFET process refinements for improved mobility and gate work function engineering. Dig Int Electron Devices Meet, 2002, 259 doi: 10.1109/IEDM.2002.1175827[11] Pherson M R M. The adjustment of mos transistor threshold voltage by ion implantation. Appl Phys Lett, 1971, 18, 502 doi: 10.1063/1.1653513[12] Lee T, Rhee S J, Kang C, et al. Structural advantage for the EOT scaling and improved electron channel mobility by incorporating dysprosium oxide (Dy2O3) into HfO2 n-MOSFETs. IEEE Electron Device Lett, 2006, 27, 640 doi: 10.1109/LED.2006.879023[13] Park J W, Baik H K, Lim T, et al. Threshold voltage control of oxide nanowire transistors using nitrogen plasma treatment. Appl Phys Lett, 2010, 97, 203508 doi: 10.1063/1.3518485[14] Fried D M, Duster J S, Kornegay K T. Improved independent gate N-type FinFET fabrication and characterization. IEEE Electron Device Lett, 2003, 24, 592 doi: 10.1109/LED.2003.815946[15] Denton J P, Neudeck G W. Fully depleted dual-gated thin-film SOI P-MOSFETs fabricated in SOI islands with an isolated buried polysilicon backgate. IEEE Electron Device Lett, 1996, 17, 509 doi: 10.1109/55.541764[16] Liu Y X, Masahara M, Ishii K, et al. Flexible threshold voltage FinFETs with independent double gates and an ideal rectangular cross-section Si-Fin channel. IEEE International Electron Devices Meeting, 2003, 18.8.1 doi: 10.1109/IEDM.2003.1269445[17] Fried D M, Duster J S, Kornegay K T. High-performance p-type independent-gate FinFETs. IEEE Electron Device Lett, 2004, 25, 199 doi: 10.1109/LED.2004.825160[18] Kumar M P V, Lin J Y, Kao K H, et al. Junctionless FETs with a fin body for multi-VTH and dynamic threshold operation. IEEE Trans Electron Devices, 2018, 65, 3535 doi: 10.1109/TED.2018.2847355[19] Ota K, Saitoh M, Tanaka C, et al. Threshold voltage control by substrate bias in 10-nm-diameter tri-gate nanowire MOSFET on ultrathin BOX. IEEE Electron Device Lett, 2013, 34, 187 doi: 10.1109/LED.2012.2234719[20] Ohtou T, Saraya T, Hiramoto T. Variable-body-factor SOI MOSFET with ultrathin buried oxide for adaptive threshold voltage and leakage control. IEEE Trans Electron Devices, 2008, 55, 40 doi: 10.1109/TED.2007.912612[21] Pelloux-Prayer B, Blagojević M, Thomas O, et al. Planar fully depleted SOI technology: The convergence of high performance and low power towards multimedia mobile applications. 2012 IEEE Faible Tension Faible Consommation, 2012, 1 doi: 10.1109/FTFC.2012.6231742[22] Yin X G, Zhang Y K, Zhu H L, et al. Vertical sandwich gate-all-around field-effect transistors with self-aligned high-k metal gates and small effective-gate-length variation. IEEE Electron Device Lett, 2020, 41, 8 doi: 10.1109/LED.2019.2954537[23] Yin X G, Zhu H L, Zhao L H, et al. Study of isotropic and Si-selective quasi atomic layer etching of Si1– xGex. ECS J Solid State Sci Technol, 2020, 9, 034012 doi: 10.1149/2162-8777/ab80ae -
Proportional views





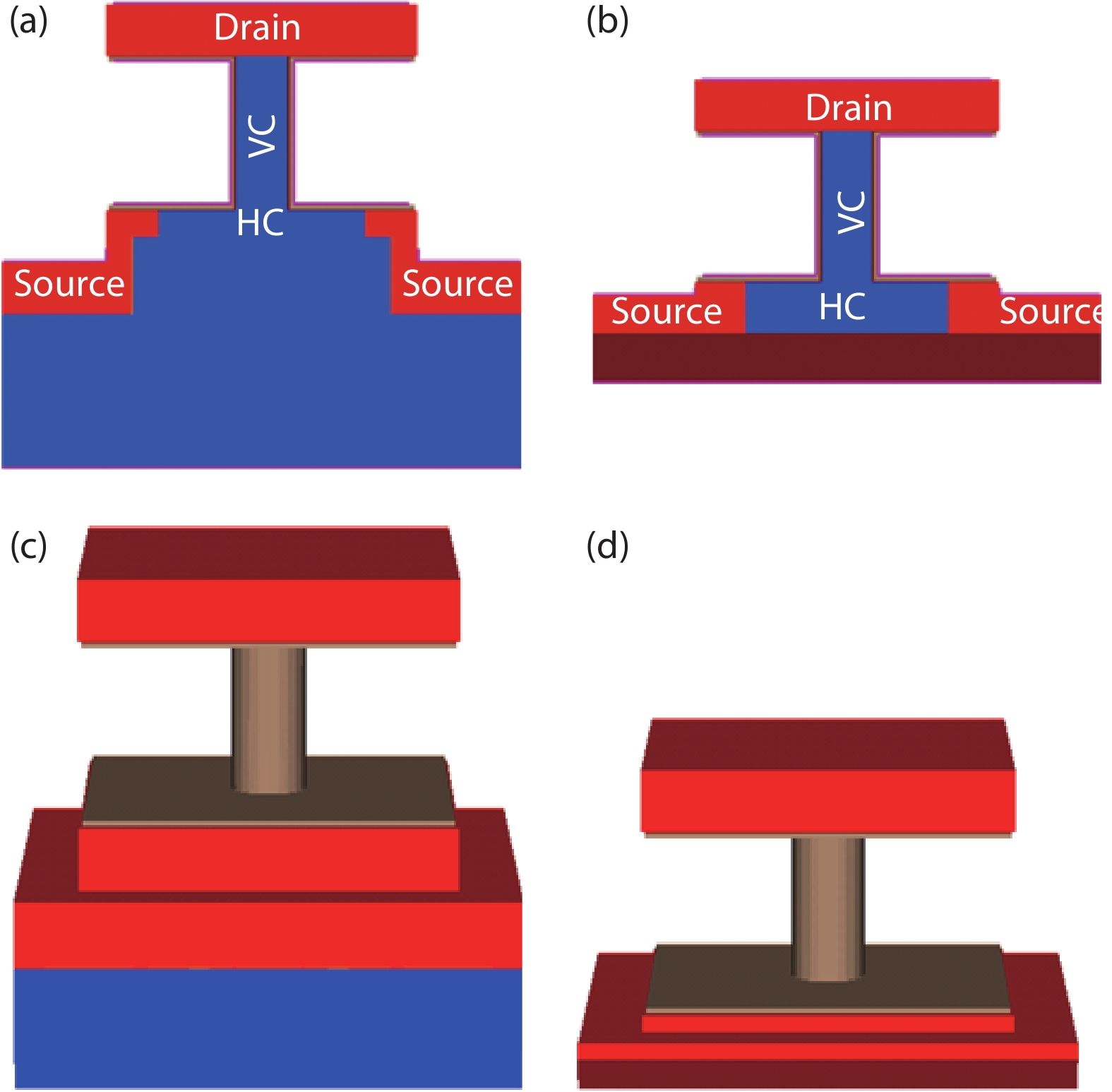
 DownLoad:
DownLoad: