| Citation: |
Guodong Gu, Shaobo Dun, Yuanjie Lü, Tingting Han, Peng Xu, Jiayun Yin, Zhihong Feng. Low ohmic contact AlN/GaN HEMTs grown by MOCVD[J]. Journal of Semiconductors, 2013, 34(11): 114004. doi: 10.1088/1674-4926/34/11/114004
****
G D Gu, S B Dun, Y Lü, T T Han, P Xu, J Y Yin, Z H Feng. Low ohmic contact AlN/GaN HEMTs grown by MOCVD[J]. J. Semicond., 2013, 34(11): 114004. doi: 10.1088/1674-4926/34/11/114004.
|
-
Abstract
AlN/GaN high-electron-mobility transistors (HEMTs) on SiC substrates were fabricated by metal-organic chemical vapor deposition (MOCVD) and then characterized. An Si/Ti/Al/Ni/Au stack was used to reduce ohmic contact resistance (0.33 Ω· mm) at a low annealing temperature. The fabricated devices exhibited a maximum drain current density of 1.07 A/mm (VGS=1 V) and a maximum peak extrinsic transconductance of 340 mS/mm. The off-state breakdown voltage of the device was 64 V with a gate-drain distance of 1.9 μm. The current gain extrinsic cutoff frequency fT and the maximum oscillation frequency fmax were 36 and 80 GHz with a 0.25 μm gate length, respectively.-
Keywords:
- AlN/GaN HEMT,
- ohmic contact,
- SiC substrate,
- MOCVD
-
References
[1] Micovic M, Kurdoghlian A, Hashimoto P, et al. GaN HFET for W-band power applications. IEDM Tech Dig, 2006:1[2] De Jaeger J C, Delage S L, Dambrine G, et al. Noise assessment of AlGaN/GaN HEMTs on Si or SiC substrates:application to X-band low noise amplifiers. European Gallium Arsenide and Other Semiconductor Application Symposium, EGAAS, 2005:229 http://core.ac.uk/display/11068817[3] Dabiran A M, Wowchak A M, Osinsky A, et al. Very high channel conductivity in low-defect AlN/GaN high electron mobility transistor structures. Appl Phys Lett, 2008, 93(8):082111 doi: 10.1063/1.2970991[4] Xing H G, Deen D, Cao Y, et al. PMBE-grown ultra-shallow AlN/GaN HFET technology. ECS Trans, 2007, 11(5):233 http://citeseerx.ist.psu.edu/viewdoc/summary?doi=10.1.1.712.3111[5] Cao Y, Jena D. High-mobility window for two-dimensional electron gases at ultrathin AlN/GaN heterojunctions. Appl Phys Lett, 2007, 90(18):182112 doi: 10.1063/1.2736207[6] Shinohara K, Regan D, Corrion A, et al. Deeply-scaled self-aligned-gate GaN DH-HEMTs with ultrahigh cut-off frequency. IEDM Tech Dig, 2011:457 http://www.mdpi.com/2079-9292/5/1/12/xml[7] Shinohara K, Regan D, Corrion A, et al. Self-aligned-gate GaN-HEMTs with heavily-doped n+-GaN ohmic contacts to 2DEG. IEDM Tech Dig, 2012:617 http://www-mtl.mit.edu/wpmu/ar2013/high-linearity-gan-hemts-with-nanowire-channel/[8] Medjdoub F, Zegaoui M, Waldhoff N, et al. Above 600 mS/mm transconductance with 2.3 A/mm drain current density AlN/GaN high-electron mobility transistors grown on silicon. Appl Phys Exp, 2011, 4(6):064106 doi: 10.1143/APEX.4.064106[9] Corrion A L, Shinohara K, Regan D, et al. High-speed AlN/GaN MOS-HFETs with scaled ALD Al2O3 gate insulators. IEEE Electron Device Lett, 2011, 32(8):1062 doi: 10.1109/LED.2011.2155616[10] Chabak K D, Walker D E, Johnson M R, et al. High-performance AlN/GaN HEMTs on sapphire substrate with an oxidized gate insulator. IEEE Electron Device Lett, 2011, 32(11):1677 http://adsabs.harvard.edu/abs/2011IEDL...32.1677C[11] Kim D W, Baik H K. Current conduction mechanism of Si/Ti-based ohmic contacts to n-GaN. Appl Phys Lett, 2000, 77(7):1011 doi: 10.1063/1.1289057[12] Lin C F, Cheng H C, Chi G C, et al. Improved contact performance of GaN film using Si diffusion. Appl Phys Lett, 2000, 76(14):1878 doi: 10.1063/1.126198[13] Mohammed F M, Wang L, Adesidaa I. First-layer Si metallizations for thermally stable and smooth ohmic contacts for AlGaN/GaN high electron mobility transistors. J Vac Sci Technol B, 2007, 25(2):324 doi: 10.1116/1.2437161 -
Proportional views





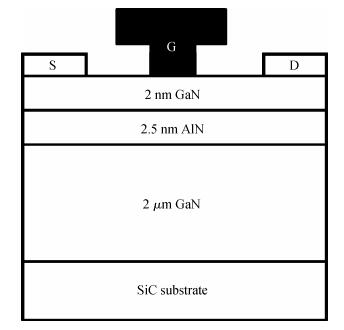
 DownLoad:
DownLoad: