| Citation: |
Yingxia Yu, Zhaojun Lin, Yuanjie Lü, Zhihong Feng, Chongbiao Luan, Ming Yang, Yutang Wang. The influence of the channel electric field distribution on the polarization Coulomb field scattering in AlN/GaN heterostructure field-effect transistors[J]. Journal of Semiconductors, 2014, 35(12): 124007. doi: 10.1088/1674-4926/35/12/124007
****
Y X Yu, Z J Lin, Y J Lü, Z H Feng, C B Luan, M Yang, Y T Wang. The influence of the channel electric field distribution on the polarization Coulomb field scattering in AlN/GaN heterostructure field-effect transistors[J]. J. Semicond., 2014, 35(12): 124007. doi: 10.1088/1674-4926/35/12/124007.
|
The influence of the channel electric field distribution on the polarization Coulomb field scattering in AlN/GaN heterostructure field-effect transistors
DOI: 10.1088/1674-4926/35/12/124007
More Information
-
Abstract
Based on the measured capacitance-voltage (C-V) curves and current-voltage (I-V) curves for the prepared differently-sized AlN/GaN heterostructure field-effect transistors (HFETs), the I-V characteristics of the AlN/GaN HFETs were simulated using the quasi-two-dimensional (quasi-2D) model. By analyzing the variation in the electron mobility for the two-dimensional electron gas (2DEG) with the channel electric field, it is found that the different polarization charge distribution generated by the different channel electric field distribution can result in different polarization Coulomb field (PCF) scattering. The 2DEG electron mobility difference is mostly caused by the PCF scattering which can reach up to 899.6 cm2/(V·s) (sample a), 1307.4 cm2/(V·s) (sample b), 1561.7 cm2/(V·s) (sample c) and 678.1 cm2/(V·s) (sample d), respectively. When the 2DEG sheet density is modulated by the drain-source bias, the electron mobility for samples a, b and c appear to peak with the variation of the 2DEG sheet density, but for sample d, no peak appears and the electron mobility rises with the increase in the 2DEG sheet density. -
References
[1] Chang C Y, Pearton S J, Lo C F, et al. Development of enhancement mode AlN/GaN high electron mobility transistors. Appl Phys Lett, 2009, 94:263505 doi: 10.1063/1.3168648[2] Shinohara K, Regan D, Corrion A, et al. Deeply-scaled self-aligned-gate DH-HEMTs with ultrahigh cutoff frequency. IEDM Tec Dig, 2011:453[3] Masataka H, Mimura T, Matsui T. AlN/GaN insulated-gate HFETs using cat-CVD SiN. IEEE Electron Device Lett, 2006, 27(9):719 doi: 10.1109/LED.2006.881087[4] Cao Y, Jena D. High-mobility window for two-dimensional electron gases at ultrathin AlN/GaN heterojunctions. Appl Phys Lett, 2007, 90:182112 doi: 10.1063/1.2736207[5] Zhao J Z, Lin Z J, Corrigan T D, et al. Electron mobility related to scattering caused by the strain variation of AlGaN barrier layer in strained AlGaN/GaN heterostructures. Appl Phys Lett, 2007, 91:173507 doi: 10.1063/1.2798500[6] Lv Y J, Lin Z J, Zhang Y, et al. Polarization Coulomb field scattering in AlGaN/AlN/GaN heterostructure field-effect transistors. Appl Phys Lett, 2011, 98:123512 doi: 10.1063/1.3569138[7] Luan C B, Lin Z J, Lv Y J, et al. Influence of the side-Ohmic contact processing on the polarization Coulomb field scattering in AlGaN/AlN/GaN heterostructure field-effect transistors. Appl Phys Lett, 2012, 101:113501 doi: 10.1063/1.4752232[8] Luan C B, Lin Z J, Feng Z H, et al. Polarization Coulomb field scattering in In0.18Al0.82N/AlN/GaN heterostructure field-effect transistors. J Appl Phys, 2012, 112:054513 doi: 10.1063/1.4752254[9] Lv Y J, Feng Z H, Han T T, et al. Enhanced effect of strain-induced polarization Coulomb field scattering in AlN/GaN heterostructure field-effect transistors. Appl Phys Lett, 2013, 103:113502 doi: 10.1063/1.4820960[10] Yu Y X, Lin Z J J, Luan C B, et al. Influence of the channel electric field distribution on the polarization Coulomb field scattering in AlGaN/AlN/GaN heterostructure field-effect transistors. AIP Advances, 2013, 3:092115 doi: 10.1063/1.4821547[11] Ridley B K, Foutz B E, Eastman L F. Mobility of electrons in bulk GaN and AlxGa1-xN/GaN heterostructures. Phys Rev B, 2000, 61(24):16862 doi: 10.1103/PhysRevB.61.16862[12] Ambacher O, Smart J, Shealy J R, et al. Two-dimensional electron gases induced by spontaneous and piezoelectric polarization charges in N-and Ga-face AlGaN/GaN heterostructures. J Appl Phys, 1999, 85(6):3222 doi: 10.1063/1.369664[13] Anwar A F M, Webster R T, Smith K V. Bias induced strain in AlGaN/GaN heterojunction field effect transistors and its implications. Appl Phys Lett, 2006, 88:203510 doi: 10.1063/1.2203739 -
Proportional views





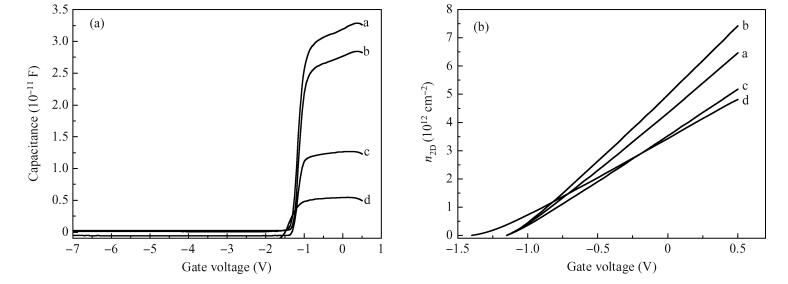
 DownLoad:
DownLoad: