| Citation: |
Ningning Sun, Manqing Tan, Ping Li, Jian Jiao, Xiaofeng Guo, Wentao Guo. Long-term storage life of light source modules by temperature cycling accelerated life test[J]. Journal of Semiconductors, 2014, 35(5): 054010. doi: 10.1088/1674-4926/35/5/054010
****
N N Sun, M Q Tan, P Li, J Jiao, X F Guo, W T Guo. Long-term storage life of light source modules by temperature cycling accelerated life test[J]. J. Semicond., 2014, 35(5): 054010. doi: 10.1088/1674-4926/35/5/054010.
|
Long-term storage life of light source modules by temperature cycling accelerated life test
DOI: 10.1088/1674-4926/35/5/054010
More Information
-
Abstract
Light source modules are the most crucial and fragile devices that affect the life and reliability of the interferometric fiber optic gyroscope (IFOG). While the light emitting chips were stable in most cases, the module packaging proved to be less satisfactory. In long-term storage or the working environment, the ambient temperature changes constantly and thus the packaging and coupling performance of light source modules are more likely to degrade slowly due to different materials with different coefficients of thermal expansion in the bonding interface. A constant temperature accelerated life test cannot evaluate the impact of temperature variation on the performance of a module package, so the temperature cycling accelerated life test was studied. The main failure mechanism affecting light source modules is package failure due to solder fatigue failure including a fiber coupling shift, loss of cooling efficiency and thermal resistor degradation, so the Norris-Landzberg model was used to model solder fatigue life and determine the activation energy related to solder fatigue failure mechanism. By analyzing the test data, activation energy was determined and then the mean life of light source modules in different storage environments with a continuously changing temperature was simulated, which has provided direct reference data for the storage life prediction of IFOG. -
References
[1] Wang Zuocai, Lv Xueqin, Jin Peng, et al. Applications of superluminescent diodes. Infrared Technol, 2010, 32(5):297 http://en.cnki.com.cn/Article_en/CJFDTOTAL-HWJS201005012.htm[2] Ma Jing, Wang Dahai, Chao Daihong, et al. Reliability evaluation of FOG based on key apparatus. Journal of Chinese Inertial Technology, 2009, 17(5):618 http://en.cnki.com.cn/Article_en/CJFDTOTAL-ZGXJ200905027.htm[3] Zhang Xiaoling, Xie Xuesong, Lv Changzhi, et al. The study on the long-term storage life of electronic components by accelerated test. Electronic Product Reliability and Environmental Testing, 2009, 27(10):7 http://en.cnki.com.cn/Article_en/CJFDTOTAL-DZKH2009S1016.htm[4] Sim S P. The reliability of laser diodes and laser transmitter modules. Microelectron Reliab, 1993, 33(7):1011 doi: 10.1016/0026-2714(93)90298-D[5] Kuang J H, Sheen M T, Chang C F, et al. Effect of temperature cycling on joint strength of PbSn and AuSn solders in laser packages. IEEE Trans Adv Packag, 2001, 24(4):563 doi: 10.1007%2Fs11664-005-0257-4.pdf[6] Hsu Y C, Huang W K, Sheen M T, et al. Fiber-alignment shifts in butterfly laser packaging by laser-welding technique:measurement and finite-element method analysis. J Electron Mater, 2004, 33(1):40 doi: 10.1007/s11664-004-0292-6[7] Manson S S, Dolan T J. Thermal stress and low cycle fatigue. J Appl Mechan, 1966, 33:957 http://www.worldcat.org/title/thermal-stress-and-low-cycle-fatigue/oclc/734953[8] Norris K C, Landzberg A H. Reliability of controlled collapse interconnections. IBM Journal of Research and Development, 1969, 13(3):266 doi: 10.1147/rd.133.0266[9] Cui H. Accelerated temperature cycle test and Coffin-Manson model for electronic packaging. IEEE Proceedings of the Reliability and Maintainability Symposium, 2005[10] Pradeep L, Aniket S, Dinesh A. Principal component analysis based development of Norris-Landzberg acceleration factors and Goldmann constants for leadfree electronics. IEEE Proceedings of the Electronic Components and Technology Conference, 2009[11] Phil I, Eddie K. Pb-free thermal cycle acceleration factors. Proceedings of the Pan Pacific Symposium Proceedings, 2010[12] Vasu V, Fan X. An acceleration model for lead-free (SAC) solder joint reliability under thermal cycling. IEEE Proceedings of the Electronic Components and Technology Conference, 2008[13] Hwang Y, Jeon H K, Ryu Y G, et al. Knowledge-based reliability qualification and an acceleration model for lead-free solder joint. IEEE Proceedings of the Electronic Components and Technology Conference (ECTC), 2011[14] GJB548B. Test methods and Procedures for microelectronic device[S]. 2005[15] Sun Mengxiang, Tan Manqing, Wang Lufeng. Life time tests of 1300 nm superluminesent diodes. Acta Optica Sinica, 2008, 28(10):1994 doi: 10.3788/AOS -
Proportional views





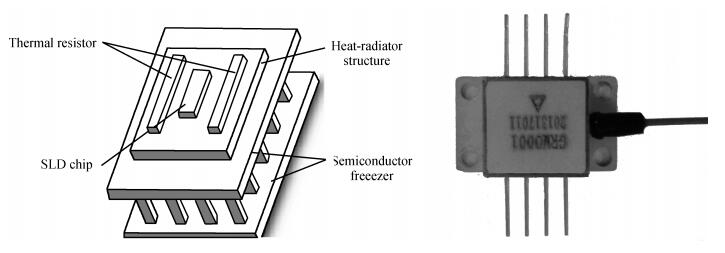
 DownLoad:
DownLoad: