| Citation: |
Chongbiao Luan, Zhaojun Lin, Yuanjie Lü, Zhihong Feng, Jingtao Zhao, Yang Zhou, Ming Yang. Comparison for the carrier mobility between the Ⅲ-Ⅴ nitrides and AlGaAs/GaAs heterostructure field-effect transistors[J]. Journal of Semiconductors, 2014, 35(9): 094007. doi: 10.1088/1674-4926/35/9/094007
****
C B Luan, Z J Lin, Y Lü, Z H Feng, J T Zhao, Y Zhou, M Yang. Comparison for the carrier mobility between the Ⅲ-Ⅴ nitrides and AlGaAs/GaAs heterostructure field-effect transistors[J]. J. Semicond., 2014, 35(9): 094007. doi: 10.1088/1674-4926/35/9/094007.
|
Comparison for the carrier mobility between the Ⅲ-Ⅴ nitrides and AlGaAs/GaAs heterostructure field-effect transistors
DOI: 10.1088/1674-4926/35/9/094007
More Information
-
Abstract
Using the measured capacitance-voltage curves of Ni/Au Schottky contacts with different areas and the current-voltage characteristics for the AlGaAs/GaAs, AlGaN/AlN/GaN and In0.18Al0.82N/AlN/GaN heterostructure field-effect transistors (HFETs) at low drain-source voltage, the two-dimensional electron gas (2DEG) electron mobility for the prepared HFETs was calculated and analyzed. It was found that there is an obvious difference for the variation trend of the mobility curves between the Ⅲ-Ⅴ nitride HFETs and the AlGaAs/GaAs HFETs. In the Ⅲ-Ⅴ nitride HFETs, the variation trend for the curves of the 2DEG electron mobility with the gate bias is closely related to the ratio of the gate length to the drain-to-source distance. While the ratio of the gate length to the drain-to-source distance has no effect on the variation trend for the curves of the 2DEG electron mobility with the gate bias in the AlGaAs/GaAs HFETs. The reason is attributed to the polarization Coulomb field scattering in the Ⅲ-Ⅴ nitride HFETs. -
References
[1] Wu Y F, Keller B P, Fini P, et al. High Al-content AlGaN/GaN MODFET's for ultrahigh performance. IEEE Electron Device Lett, 1998, 19(2):50 doi: 10.1109/55.658600[2] Sullivan G J, Chen M Y, Higgins J A, et al. High-power 10 GHz operation of AlGaN HFET's on insulating SiC. IEEE Electron Device Lett, 1998, 19(6):198 doi: 10.1109/55.678543[3] Chen Q, Yang J W, Gaska R, et al. High-power microwave 0.25-μm gate doped-channel GaN/AlGaN heterostructure field effect transistor. IEEE Electron Device Lett, 1998, 19(2):44 doi: 10.1109/55.658598[4] Dang X Z, Asbeck P M, Yu E T, et al. Measurement of drift mobility in AlGaN/GaN heterostructure field-effect transistor. Appl Phys Lett, 1999, 74(25):3890 doi: 10.1063/1.124214[5] Luan C B, Lin Z J, Lv Y J, et al. Influence of the side-ohmic contact processing on polarization Coulomb field scattering in AlGaN/AlN/GaN heterostructure field-effect transistors. Appl Phys Lett, 2012, 101(11):113501 doi: 10.1063/1.4752232[6] González-Posada Flores F, Rivera C, Muñoz E. The effects of processing of high-electron-mobility transistors on the strain state and the electrical properties of AlGaN/GaN structures. Appl Phys Lett, 2009, 95(20):203504 doi: 10.1063/1.3263955[7] Anwar A F M, Webster R T, Smith K V. Bias induced strain in AlGaN/GaN heterojunction field effect transistors and its implications. Appl Phys Lett, 2006, 88(20):203510 doi: 10.1063/1.2203739[8] Zhao J Z, Lin Z J, Corrigan T D, et al. Electron mobility related to scattering caused by the strain variation of AlGaN barrier layer in strained AlGaN/GaN heterostructures. Appl Phys Lett, 2007, 91(17):173507 doi: 10.1063/1.2798500[9] Lv Y J, Lin Z J, Zhang Y, et al. Polarization Coulomb field scattering in AlGaN/AlN/GaN heterostructure field-effect transistors. Appl Phys Lett, 2011, 98(12):123512 doi: 10.1063/1.3569138[10] Lv Y J, Lin Z J, Meng L G, et al. Influence of the ratio of gate length to drain-to-source distance on the electron mobility in AlGaN/AlN/GaN heterostructure field-effect transistors. Nanoscale Research Lett, 2012, 7(1):434 doi: 10.1186/1556-276X-7-434[11] Luan C B, Lin Z J, Feng Z H, et al. Polarization coulomb field scattering in In0.18Al0.82N/AlN/GaN heterostructure field-effect transistors. J Appl Phys, 2012, 112(5):054513 doi: 10.1063/1.4752254[12] Hirakawa K, Sakaki H. Mobility of the two-dimensional electron gas at selectively doped n-type AlxGa1-xAs/GaAs heterojunctions with controlled electron concentrations. Phys Rev B, 1986, 33(12):8291 doi: 10.1103/PhysRevB.33.8291[13] Ridley B K, Foutz B E, Eastman L F. Mobility of electrons in bulk GaN and AlxGa1-xN/GaN heterostructures. Phys Rev B, 2000, 61(24):16862 doi: 10.1103/PhysRevB.61.16862 -
Proportional views





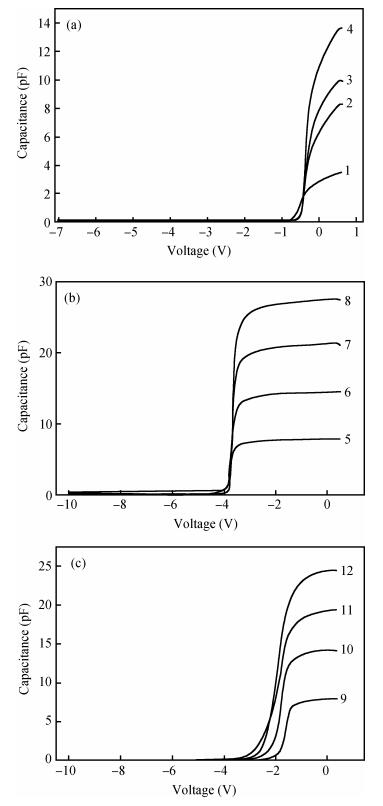
 DownLoad:
DownLoad: