| Citation: |
Haiwen Deng, Baimei Tan, Baohong Gao, Chenwei Wang, Zhangbing Gu, Yan Zhang. A novel cleaner for colloidal silica abrasive removal in post-Cu CMP cleaning[J]. Journal of Semiconductors, 2015, 36(10): 106002. doi: 10.1088/1674-4926/36/10/106002
****
H W Deng, B M Tan, B H Gao, C W Wang, Z B Gu, Y Zhang. A novel cleaner for colloidal silica abrasive removal in post-Cu CMP cleaning[J]. J. Semicond., 2015, 36(10): 106002. doi: 10.1088/1674-4926/36/10/106002.
|
A novel cleaner for colloidal silica abrasive removal in post-Cu CMP cleaning
DOI: 10.1088/1674-4926/36/10/106002
-
Abstract
A novel cleaning solution, named FA/O alkaline cleaner, was proposed and demonstrated in the removal of colloidal silica abrasives.In order to remove both the chemical and physical absorbed colloidal silica abrasives, an FA/OII chelating agent and non-ionic surfactant were added into the cleaner.By varying the concentration of chelating agent and non-ionic surfactant, a series of experiments were performed to determine the best cleaning results.This paper discusses the mechanism of the removal of colloidal silica abrasives with a FA/O alkaline cleaner.Based on the experiment results, it is concluded that both the FA/OII chelating and non-ionic surfactant could benefit the removal of colloidal silica abrasives.When the concentration of FA/OII chelating agent and FA/O non-ionic surfactant reached the optima value, it was demonstrated that silica abrasives could be removed efficiently by this novel cleaning solution. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] -
Proportional views





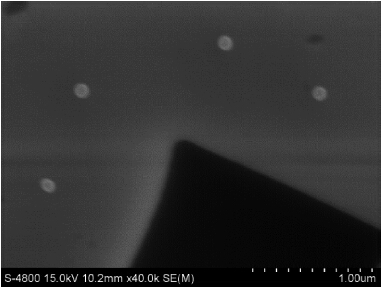
 DownLoad:
DownLoad: