| Citation: |
Mengxuan Jiang, Z. John Shen, Jun Wang, Xin Yin, Zhikang Shuai, Jiang Lu. A high-conductivity insulated gate bipolar transistor with Schottky hole barrier contact[J]. Journal of Semiconductors, 2016, 37(2): 024011. doi: 10.1088/1674-4926/37/2/024011
****
M X Jiang, Z. John Shen, J Wang, X Yin, Z K Shuai, J Lu. A high-conductivity insulated gate bipolar transistor with Schottky hole barrier contact[J]. J. Semicond., 2016, 37(2): 024011. doi: 10.1088/1674-4926/37/2/024011.
|
A high-conductivity insulated gate bipolar transistor with Schottky hole barrier contact
DOI: 10.1088/1674-4926/37/2/024011
More Information
-
Abstract
This letter proposes a high-conductivity insulated gate bipolar transistor (HC-IGBT) with Schottky contact formed on the p-base, which forms a hole barrier at the p-base side to enhance the conductivity modulation effect. TCAD simulation shows that the HC-IGBT provides a current density increase by 53% and turn-off losses decrease by 27% when compared to a conventional field-stop IGBT (FS-IGBT). Hence, the proposed IGBT exhibits superior electrical performance for high-efficiency power electronic systems.-
Keywords:
- breakdown voltage,
- conductivity modulation,
- current density,
- latch up,
- IGBT
-
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] -
Proportional views





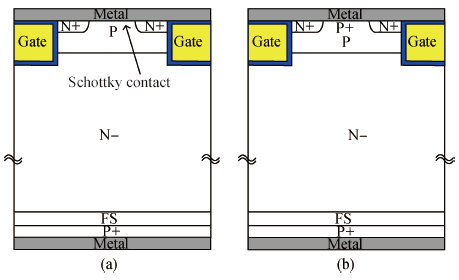
 DownLoad:
DownLoad: