| Citation: |
Degang Zhao. III-nitride based ultraviolet laser diodes[J]. Journal of Semiconductors, 2019, 40(12): 120402. doi: 10.1088/1674-4926/40/12/120402
****
D G Zhao, III-nitride based ultraviolet laser diodes[J]. J. Semicond., 2019, 40(12): 120402. doi: 10.1088/1674-4926/40/12/120402.
|
-
References
[1] Nakamura S, Senoh M, Nagahama S, et al. InGaN/GaN/AlGaN-based laser diodes with modulation-doped strained-layer superlattices grown on an epitaxially laterally overgrown GaN substrate. Appl Phys Lett, 1998, 72, 211 doi: 10.1063/1.120688[2] Nagahama S, Yanamoto T, Sano M, et al. Ultraviolet GaN single quantum well laser diodes. Jpn J Appl Phys, 2001, 40, L785 doi: 10.1143/JJAP.40.L785[3] Nagahama S, Yanamoto T, Sano M, et al. Characteristics of ultraviolet laser diodes composed of quaternary AlxInyGa(1– x – y)N. Jpn J Appl Phys, , 2001, 40, L788 doi: 10.1143/JJAP.40.L788[4] Masui S, Matsuyama Y, Yanamoto T, et al. 365 nm ultraviolet laser diodes composed of quaternary AlInGaN alloy. Jpn J Appl Phys, 2003, 42, L 1318 doi: 10.1143/JJAP.42.L1318[5] Iida K, Kawashima T, Miyazaki A, et al. 350.9 nm UV laser diode grown on low-dislocation-density AlGaN. Jpn J Appl Phys, 2004, 43, L499 doi: 10.1143/JJAP.43.L499[6] Yoshida H, Yamashita Y, Kuwabara M, et al. A 342-nm ultraviolet AlGaN multiple-quantum-well laser diode. Nat Photonics, 2008, 2, 551 doi: 10.1038/nphoton.2008.135[7] Yoshida H, Yamashita Y, Kuwabara M, et al. Demonstration of an ultraviolet 336 nm AlGaN multiple-quantum-well laser diode. Appl Phys Lett, 2008, 93, 241106 doi: 10.1063/1.3050539[8] Zhao D G, Yang J, Liu Z S, et al. Fabrication of room temperature continuous-wave operation GaN-based ultraviolet laser diodes. J Semicond, 2017, 38, 051001 doi: 10.1088/1674-4926/38/5/051001[9] Li D B, Jiang K, Sun X J, et al. AlGaN photonics: recent advances in materials and ultraviolet devices. Adv Opt Photonics, 2018, 10, 43 doi: 10.1364/AOP.10.000043[10] Zhang Z Y, Kushimoto M, Sakai T, et al. A 271.8 nm deep-ultraviolet laser diode for room temperature operation. Appl Phys Express, 2019, 12, 124003 doi: 10.7567/1882-0786/ab50e0 -
Proportional views





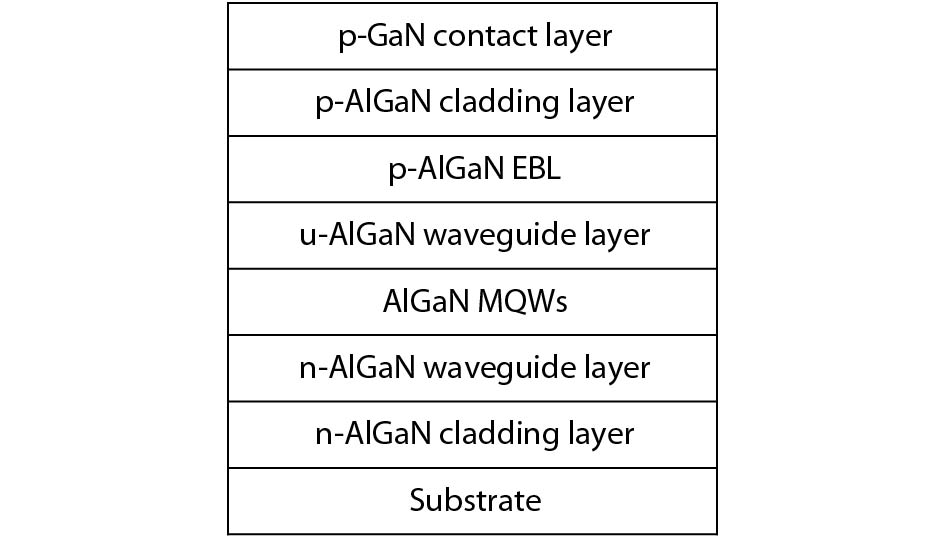
 DownLoad:
DownLoad:














