| Citation: |
Zhaohuan Tang, Rongkan Liu, Kaizhou Tan, Jun Luo, Gangyi Hu, Ruzhang Li, Huaping Ren, Bin Wang. A novel terminal structure for total dose irradiation hardened of a P-VDMOS[J]. Journal of Semiconductors, 2014, 35(5): 054005. doi: 10.1088/1674-4926/35/5/054005
****
Z H Tang, R K Liu, K Z Tan, J Luo, G Y Hu, R Z Li, H P Ren, B Wang. A novel terminal structure for total dose irradiation hardened of a P-VDMOS[J]. J. Semicond., 2014, 35(5): 054005. doi: 10.1088/1674-4926/35/5/054005.
|
A novel terminal structure for total dose irradiation hardened of a P-VDMOS
DOI: 10.1088/1674-4926/35/5/054005
More Information
-
Abstract
Using positive surface charge instead of traditional γ-ray total dose irradiation, the electric field distribution of a P-channel VDMOS terminal has been analyzed. A novel terminal structure for improving the total dose irradiation hardened of P-channel VDMOS has been proposed, and the structure is simulated and demonstrated with a -150 V P-channel VDMOS. The results show that the peak current density is reduced from 5.51×103 A/cm2 to 2.01×103 A/cm2, and the changed value of the breakdown voltage is 2.5 V at 500 krad(Si). Especially, using 60Co and X-ray to validate the results, which strictly match with the simulated values, there is not any added mask or process to fabricate the novel structure, of which the process is compatible with common P-channel VDMOS processes. The novel terminal structure can be widely used in total irradiation hardened P-channel VDMOS design and fabrication, which holds a great potential application in the space irradiation environment. -
References
[1] Li Zehong, Zhang Lei, Tan Kaizhou. Total dose radiation hardened power VDMOS device. Journal of UESTC, 2008, 37(4):621(in Chinese)[2] Raparla V A K, Lee S C, Schrimpf R D, et al. A model of radiation effects in nitride-oxide films for power MOSFET applications. Solid-State Electron, 2003, 47:775 doi: 10.1016/S0038-1101(02)00375-1[3] Gao Bo, Yu Xuefeng, Ren Diyuan, et al. Total ionizing dose effects and annealing behavior for domestic VDMOS devices. Journal of Semiconductors, 2010, 31(4):044007 doi: 10.1088/1674-4926/31/4/044007[4] Cai Xiaowu, Hai Chaohe, Wang Lixin, et al. Gamma irradiation induced oxide trapped charge and interface charge in power VDMOS. Journal of Functional Material and Devices, 2008, 14(5):621(in Chinese)[5] Xue Yuxiong, Cao Zhou, Guo Zuyou, et al. Study of total ionization dose test of power MOSFET for satellite application. Nuclear Electronics & Detection Technology, 2008, 28(3):538(in Chinese) -
Proportional views





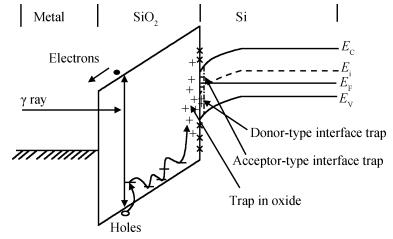
 DownLoad:
DownLoad: