| Citation: |
Jiao Hong, Yuling Liu, Baoguo Zhang, Xinhuan Niu, Liying Han. A new kind of chelating agent with low pH value applied in the TSV CMP slurry[J]. Journal of Semiconductors, 2015, 36(12): 126001. doi: 10.1088/1674-4926/36/12/126001
****
J Hong, Y L Liu, B G Zhang, X H Niu, L Y Han. A new kind of chelating agent with low pH value applied in the TSV CMP slurry[J]. J. Semicond., 2015, 36(12): 126001. doi: 10.1088/1674-4926/36/12/126001.
|
A new kind of chelating agent with low pH value applied in the TSV CMP slurry
DOI: 10.1088/1674-4926/36/12/126001
More Information
-
Abstract
TSV(through silicon via) is an emerging technology, which can realize micromation compared with the conventional packaging and extend Moore's law. Chemical mechanical polishing(CMP) is one of the most important steps in the process of TSV manufacture, and it is an enabling technology to extend Moore's law in the past two decades. Low pressure, low abrasive and low pH value are the main requirements for copper interconnection. In this paper, the effect of different kinds of TSV slurry with FA/O Ⅱ or FA/O IV type chelating agent on CMP are studied. All kinds of slurry used in this study are alkaline with no added inhibitors. From the experiment results, it can be seen that the copper removal rate and surface roughness achieved by using the FA/O IV type chelating agent with a low pH value is superior to using the FA/O Ⅱ type chelating agent. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] -
Proportional views





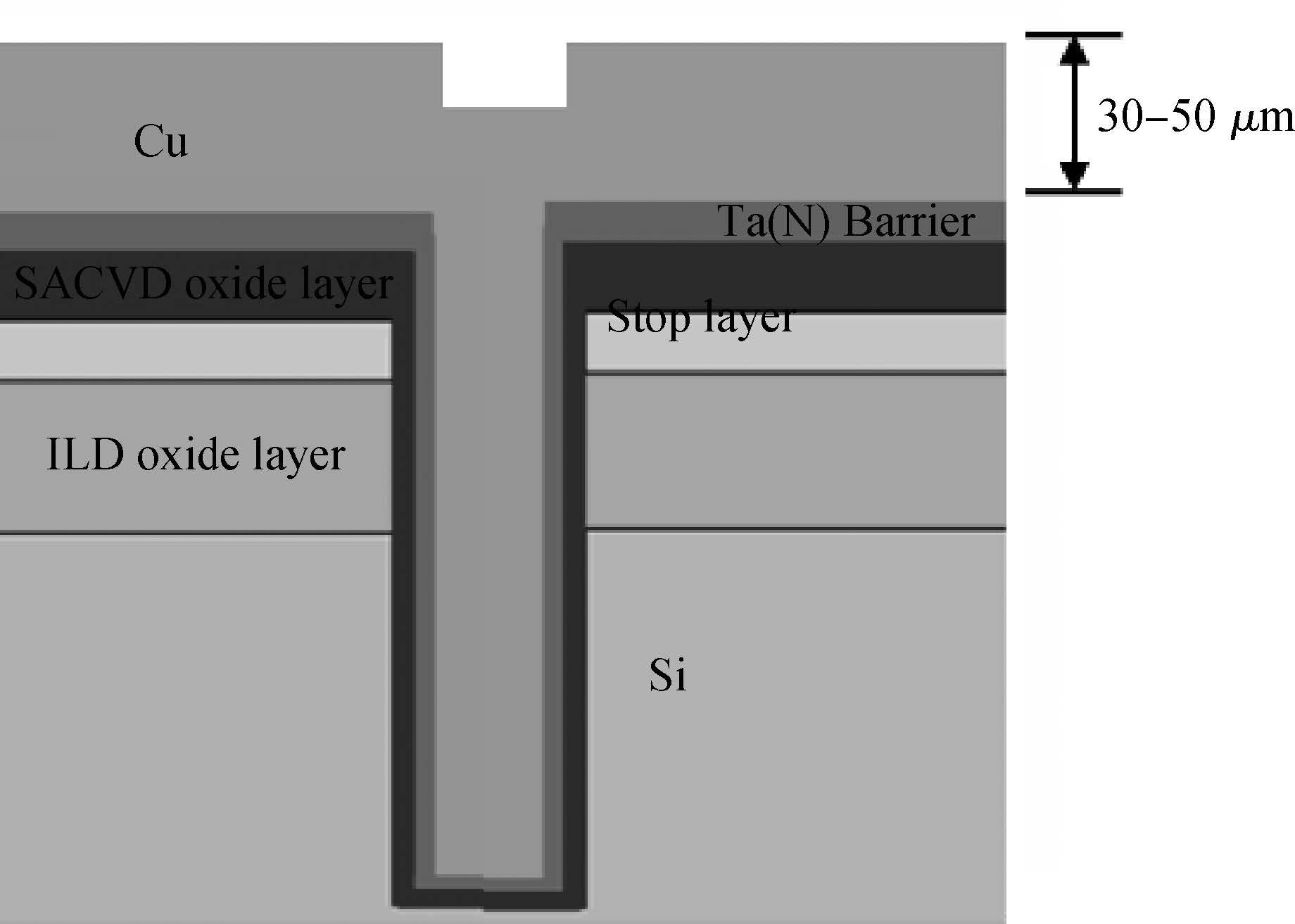
 DownLoad:
DownLoad:




















