| Citation: |
Zhaoxiang Han, Weihai Fan. Mechanism investigation of pre-existing void-induced multi-modal electro-migration behavior[J]. Journal of Semiconductors, 2022, 43(5): 054103. doi: 10.1088/1674-4926/43/5/054103
****
Z X Han, W H Fan. Mechanism investigation of pre-existing void-induced multi-modal electro-migration behavior[J]. J. Semicond, 2022, 43(5): 054103. doi: 10.1088/1674-4926/43/5/054103
|
Mechanism investigation of pre-existing void-induced multi-modal electro-migration behavior
DOI: 10.1088/1674-4926/43/5/054103
More Information
-
Abstract
A multi-modal time-to-failure distribution for an electro-migration (EM) structure has been observed and studied from long duration in-situ EM experiment, for which the failure mechanism has been investigated and discussed comprehensively. The mixed EM failure behavior strongly suggest that the fatal voids induced EM failure appear at various locations along the EM structure. This phenomenon is believed to be highly related to the existence of pre-existing voids before EM stress. Meanwhile, the number and location of the pre-existing voids can influence the EM failure mode significantly. Based on our research, a potential direction to improve the EM lifetime of Cu interconnect is presented.-
Keywords:
- reliability,
- electro-migration,
- multi-modal,
- pre-existing void
-
References
[1] Strong A W, Wu E Y, Vollertsen R P, et al. Reliability wearout mechanisms in advanced CMOS technologies. John Wiley & Sons, 2009[2] Hau-Riege C S. An introduction to Cu electromigration. Microelectron Reliab, 2004, 44(2), 195 doi: 10.1016/j.microrel.2003.10.020[3] Korhonen M A, Bo/rgesen P, Tu K N, et al. Stress evolution due to electromigration in confined metal lines. J Appl Phys, 1993, 73(8), 3790 doi: 10.1063/1.354073[4] Meyer M A, Herrmann M, Langer E, et al. In situ SEM observation of electromigration phenomena in fully embedded copper interconnect structures. Microelectron Eng, 2002, 64(1–4), 375 doi: 10.1016/S0167-9317(02)00811-0[5] Lloyd J R. Electromigration failure. J Appl Phys, 1991, 69(11), 7601 doi: 10.1063/1.347529[6] Filippi R G, Wang P C, Brendler A, et al. The effect of a threshold failure time and bimodal behavior on the electromigration lifetime of copper interconnects. 2009 IEEE International Reliability Physics Symposium, 2009, 444 doi: 10.1109/IRPS.2009.5173295[7] Hu C K, Harper J M E. Copper interconnections and reliability. Mater Chem Phys, 1998, 52(1), 5 doi: 10.1016/S0254-0584(98)80000-X[8] Gan C L, Thompson C V, Pey K L, et al. Effect of current direction on the lifetime of different levels of Cu dual-damascene metallization. Appl Phys Lett, 2001, 79(27), 4592 doi: 10.1063/1.1428410[9] Dai Y Y, Ng M Z, Anantha P, et al. Enhanced copper micro/nano-particle mixed paste sintered at low temperature for 3D interconnects. Appl Phys Lett, 2016, 108(26), 263103 doi: 10.1063/1.4954966[10] Lane M W, Liniger E G, Lloyd J R. Relationship between interfacial adhesion and electromigration in Cu metallization. J Appl Phys, 2003, 93(3), 1417 doi: 10.1063/1.1532942[11] Rosenberg R, Edelstein D C, Hu C K, et al. Copper metallization for high performance silicon technology. Ann Rev Mater Sci, 2000, 30(1), 229 doi: 10.1146/annurev.matsci.30.1.229[12] Mario H, Lim M K, Gan C L. Impact of pre-existing voids on electromigration in copper interconnects. 2012 19th IEEE International Symposium on the Physical and Failure Analysis of Integrated Circuits, 2012, 1 doi: 10.1109/IPFA.2012.6306330[13] Choi Z S, Lee J, Lim M K, et al. Void dynamics in copper-based interconnects. J Appl Phys, 2011, 110(3), 033505 doi: 10.1063/1.3611408 -
Proportional views





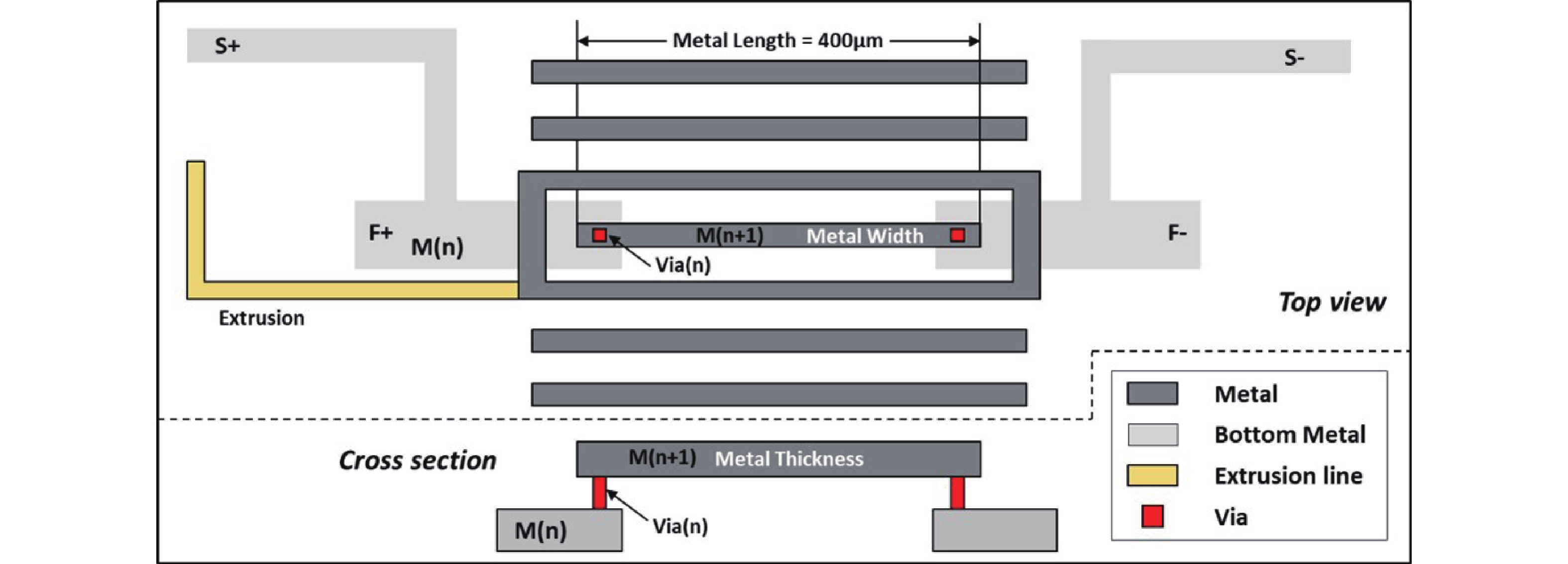
 DownLoad:
DownLoad: