| Citation: |
Jifei Sang, Libo Qian, Yinshui Xia, Huakang Xia. Design of a 3D Wilkinson power divider using through glass via technology[J]. Journal of Semiconductors, 2018, 39(12): 125007. doi: 10.1088/1674-4926/39/12/125007
****
J F Sang, L B Qian, Y S Xia, H K Xia, Design of a 3D Wilkinson power divider using through glass via technology[J]. J. Semicond., 2018, 39(12): 125007. doi: 10.1088/1674-4926/39/12/125007.
|
Design of a 3D Wilkinson power divider using through glass via technology
DOI: 10.1088/1674-4926/39/12/125007
More Information
-
Abstract
Due to its low electrical loss and low process cost, a glass interposer has been developed to provide a compelling alternative to the silicon-based interposer for packaging of future 2-D and 3-D ICs. In this study, through glass vias (TGVs) are used to implement 3-D inductors for minimal footprint and large quality factor. Using the inductors and parallel plate capacitors, a compact 3-D Wilkinson power divider is designed and analyzed. Compared with some reported power dividers, the proposed TGV-based circuit has an ultra-compact size and excellent electrical performance.-
Keywords:
- 3D integration,
- glass interposer,
- through glass vias,
- power divider
-
References
[1] Zhang R, Jeffery C C, Lee W R. Design and fabrication of a silicon interposer with TSVs in cavities for three dimensional IC packaging. IEEE Trans Device Mater Reliab, 2012, 12(2): 189 doi: 10.1109/TDMR.2012.2190764[2] Yin X, Zhu Z, Yang Y, et al. Effectiveness of p+ layer in mitigating substrate noise induced by through silicon via for microwave applications. IEEE Microwave Wireless Compon Lett, 2016, 26(9): 687 doi: 10.1109/LMWC.2016.2597218[3] Wang F, Zhu Z, Yang Y, et al. An effective approach of reducing the keep out zone induced by coaxial through silicon via. IEEE Trans Electron Devices, 2014, 61(8): 2928 doi: 10.1109/TED.2014.2330838[4] Lu J Q. 3-D hyper integration and packaging technologies for mico-nanosystems. Proc IEEE, 2009, 97(1): 18 doi: 10.1109/JPROC.2008.2007458[5] Lee S, Chen K. Development of bump less stacking with bottom-up TSV fabrication. IEEE Trans Electron Devices, 2017, 64(4): 1660 doi: 10.1109/TED.2017.2657324[6] Sukumaran V, Bandyopadhyay T, Sundaram V, et al. Low cost thin glass interposers as a superior alternative to silicon and organic interposers for packaging of 3D ICs. IEEE Trans Compon, Pack Manuf Technol, 2012, 2(9): 1426 doi: 10.1109/TCPMT.2012.2204392[7] Sukumaran V, Kumar G, Ramachandran K, et al. Design, fabrication and characterization of ultrathin 3-D glass interposers with through package vias at same pitch as TSVs in silicon. IEEE Trans Compon, Pack Manuf Technol, 2014, 4(5): 786 doi: 10.1109/TCPMT.2014.2303427[8] Li J, Wei X C, Li E P. Accurate field circuit hybrid modeling of high density through glass via arrays using perfect magnetic conductors and cylindrical mode expansion. IEEE Trans Compon, Pack Manuf Technol, 2016, 6(1): 100 doi: 10.1109/TCPMT.2015.2503362[9] Cho S, Sundaram V, Tummala R R, et al. Impact of copper through package vias on thermal performance of glass interposers. IEEE Trans Compon, Pack Manuf Technol, 2015, 5(8): 1075 doi: 10.1109/TCPMT.2015.2450731[10] Hsieh Y C, Chang Y S, Lee T C, et al. Characterization of through glass via (TGV) RF inductors. International Microsystems, Packaging, Assembly and Circuits Technology Conference, 2016: 87[11] Kim J, Shenoy R, Lai K Y, et al. High-Q 3D RF solenoid inductors in glass. IEEE Radio Frequency Integrated Circuits Symposium, 2014: 199[12] Liu M, Wei X, Wang P, et al. Compact LTCC multilayer broadband power divider. International Conference on Computational Problem-Solving, 2011: 370[13] D M Pozar. Microwave engineering. 3rd ed. CA: John Wiley & Sons, 2005: 274[14] Yu T. A broadband Wilkinson power divider based on the segmented structure. IEEE Trans Microwave Theory Tech, 2018, 66(4): 1902 doi: 10.1109/TMTT.2018.2799579[15] Wang X, Takahashi K, Okamura S, et al. Generalized port separation dual-band Wilkinson power divider with series RLC components. Microwave Conference, 2011: 289[16] Manual of Advanced Design System v2016.01[Online]. Available: https://www.keysight.com/cn/zh/products/design-software.html[17] Krishnamurthy H K, Weng S, Mathew G E, et al. A 500 MHz, 68% efficient, fully on-die digitally controlled buck voltage regulator on 22 nm Tri-gate CMOS. VLSI Dig Tech Papers, 2014: 1[18] Manual of HFSS v15[Online]. Available: http://www.aonesoft.net/ansys/hfss.html[19] Yu T, Tsai J. Design of multi way power dividers including all connecting lines. IET Microwave, Antenna & Propagation, 2018, 12(8): 1367[20] Shao J, Huang S, Pang Y. Wilkinson power divider incorporating quasi-elliptic filters for improved out of band rejection. Electron Lett, 2011, 47(23): 1288 doi: 10.1049/el.2011.2766[21] Wu D, Li Y, Xue Q. Filtering power divider with harmonic suppression based on LTCC broadside coupling. Electron Lett, 2018, 54(11): 697 doi: 10.1049/el.2018.1025[22] Zhou B. Broadband and compact LTCC power divider. Electron Lett, 2015, 51(23): 1939 doi: 10.1049/el.2015.2265 -
Proportional views





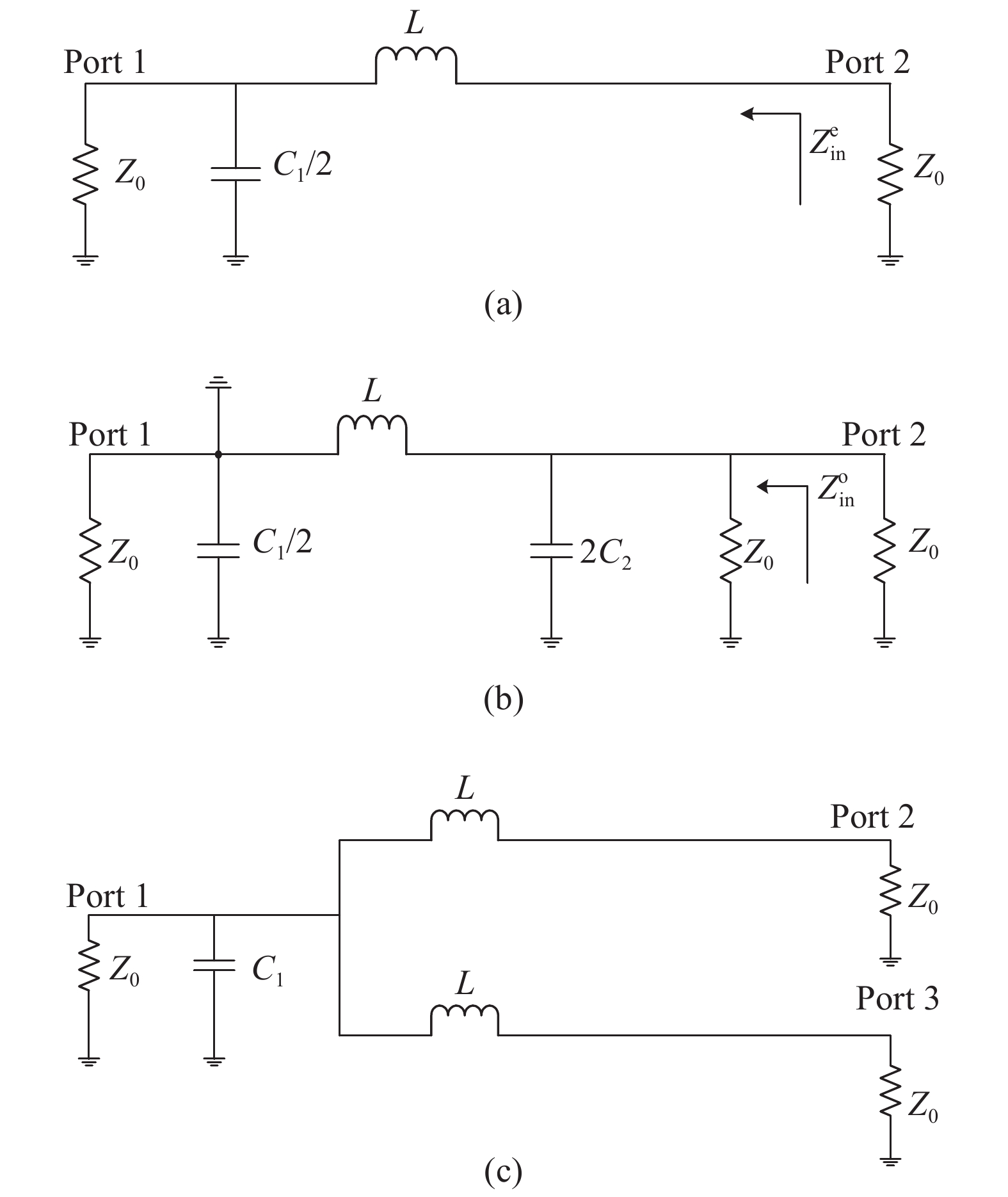
 DownLoad:
DownLoad: