| Citation: |
Wen Fang, Eddy Simoen, Chikang Li, Marc Aoulaiche, Jun Luo, Chao Zhao, Cor Claeys. Silicon-film-related random telegraph noise in UTBOX silicon-on-insulator nMOSFETs[J]. Journal of Semiconductors, 2015, 36(9): 094005. doi: 10.1088/1674-4926/36/9/094005
****
W Fang, E Simoen, C K Li, M Aoulaiche, J Luo, C Zhao, C Claeys. Silicon-film-related random telegraph noise in UTBOX silicon-on-insulator nMOSFETs[J]. J. Semicond., 2015, 36(9): 094005. doi: 10.1088/1674-4926/36/9/094005.
|
Silicon-film-related random telegraph noise in UTBOX silicon-on-insulator nMOSFETs
DOI: 10.1088/1674-4926/36/9/094005
More Information
-
Abstract
This paper studies the amplitude of random telegraph noise (RTN) caused by a single trap in the silicon film of ultra-thin buried oxide (UTBOX) silicon-on-insulator (SOI) devices. The film-defect-related RTN was identified and analyzed by low frequency noise measurement and time domain measurement. Emphasis is on the relative amplitude ΔID/ID, which is studied in the function of the front-gate, the back-gate and the drain-to-source biases. Interesting asymmetric or symmetric VDS dependence of switched source and drain are observed and supported by calibrated Sentaurus simulations. It is believed the asymmetry of the VDS dependence of the switched source and drain is related to the lateral trap position along the source and drain. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] [15] [16] [17] [18] [19] [20] [21] [22] [23] [24] [25] [26] -
Proportional views





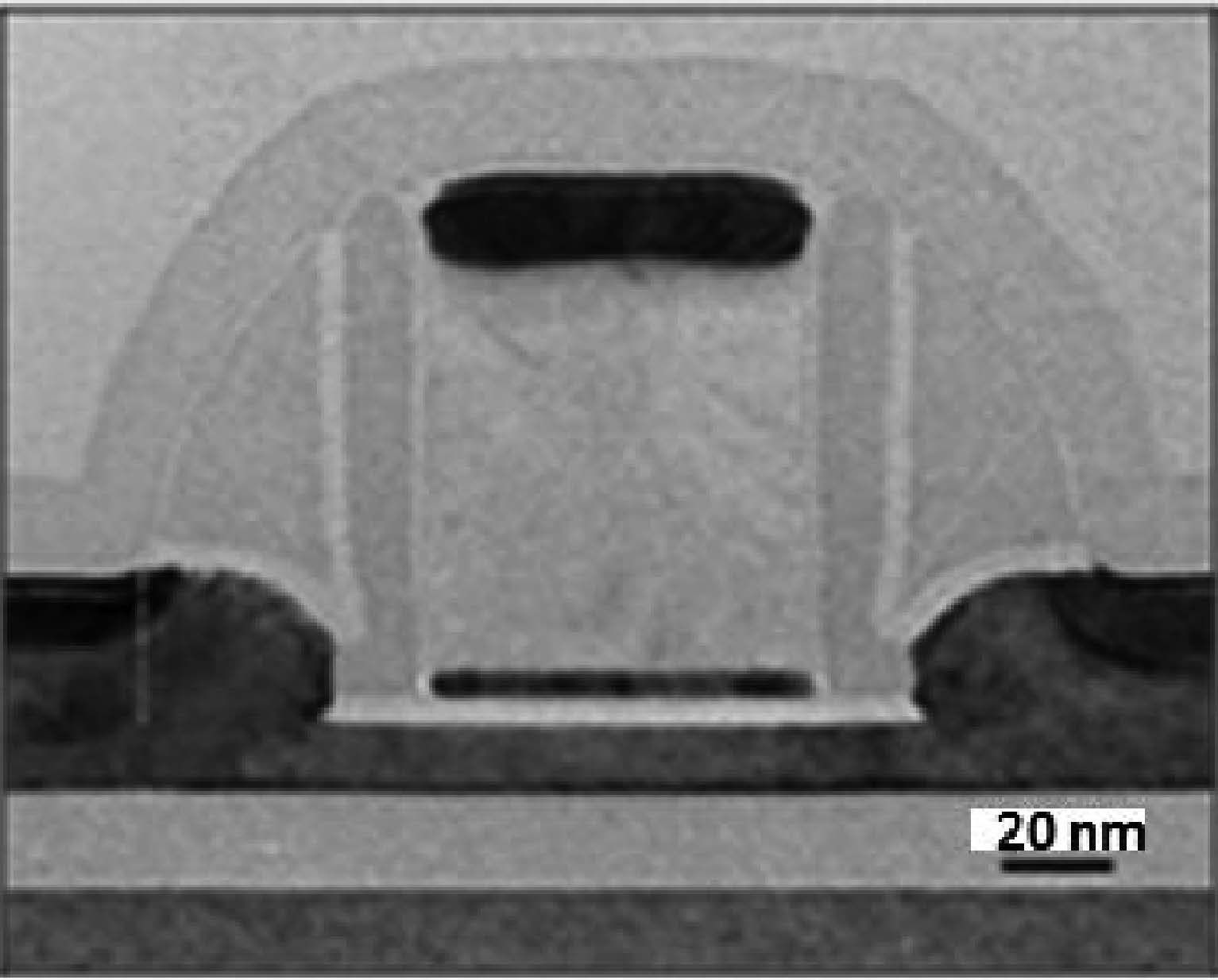
 DownLoad:
DownLoad: