| Citation: |
Chunlei Ma, Guodong Gu, Yuanjie Lü. A high performance InAlN/GaN HEMT with low Ron and gate leakage[J]. Journal of Semiconductors, 2016, 37(2): 024009. doi: 10.1088/1674-4926/37/2/024009
****
C L Ma, G D Gu, Y Lü. A high performance InAlN/GaN HEMT with low Ron and gate leakage[J]. J. Semicond., 2016, 37(2): 024009. doi: 10.1088/1674-4926/37/2/024009.
|
A high performance InAlN/GaN HEMT with low Ron and gate leakage
DOI: 10.1088/1674-4926/37/2/024009
More Information
-
Abstract
InAlN/GaN high-electron mobility transistors (HEMTs) with a gate length of 100 nm and oxygen plasma treatment were fabricated. A Si/Ti/Al/Ni/Au ohmic contact was also used to reduce the contact resistance. DC and RF characteristics of the devices were measured. The fabricated devices show a maximum drain current density of 2.18 A/mm at VGS = 2 V, a low on-resistance (Ron) of 1.49 Ω·mm and low gate leakage current. An excellent frequency response was also obtained. The current cut-off frequency (fT) is 81 GHz and the maximum oscillation frequency is 138 GHz, respectively. -
References
[1] [2] [3] [4] [5] [6] [7] [8] [9] [10] [11] [12] [13] [14] -
Proportional views





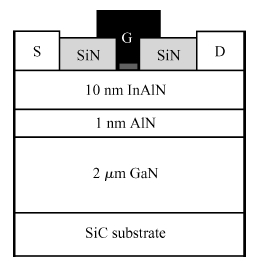
 DownLoad:
DownLoad: