| Citation: |
Xubo Song, Guodong Gu, Shaobo Dun, Yuanjie Lü, Tingting Han, Yuangang Wang, Peng Xu, Zhihong Feng. DC and RF characteristics of enhancement-mode InAlN/GaN HEMT with fluorine treatment[J]. Journal of Semiconductors, 2014, 35(4): 044002. doi: 10.1088/1674-4926/35/4/044002
****
X B Song, G D Gu, S B Dun, Y Lü, T T Han, Y G Wang, P Xu, Z H Feng. DC and RF characteristics of enhancement-mode InAlN/GaN HEMT with fluorine treatment[J]. J. Semicond., 2014, 35(4): 044002. doi: 10.1088/1674-4926/35/4/044002.
|
DC and RF characteristics of enhancement-mode InAlN/GaN HEMT with fluorine treatment
DOI: 10.1088/1674-4926/35/4/044002
More Information
-
Abstract
We report an enhancement-mode InAlN/GaN HEMT using a fluorine plasma treatment. The threshold voltage was measured to be +0.86 V by linear extrapolation from the transfer characteristics. The transconductance is 0 mS/mm at VGS=0 V and VDS=5 V, which shows a truly normal-off state. The gate leakage current density of the enhancement-mode device shows two orders of magnitude lower than that of the depletion-mode device. The transfer characteristics of the E-mode InAlN/GaN HEMT at room temperature and high temperature are reported. The current gain cut-off frequency (fT) and the maximum oscillation frequency (fmax) of the enhancement-mode device with a gate length of 0.3 μm were 29.4 GHz and 37.6 GHz respectively, which is comparable with the depletion-mode device. A classical 16 elements small-signal model was deduced to describe the parasitic and the intrinsic parameters of the device. -
References
[1] Medjdoub F, Carlin J F, Gonschorek M, et al. Can InAlN/GaN be an alternative to high power/high temperature AlGaN/GaN devices. IEDM Tech Dig, 2006:927 http://ieeexplore.ieee.org/xpl/articleDetails.jsp?reload=true&arnumber=4154370[2] Liu Bo, Feng Zhihong, Zhang Sen, et al. A 4.69 W/mm output power density InAlN/GaN HEMT grown on sapphire. Journal of Semiconductors, 2011, 32(12):124003 doi: 10.1088/1674-4926/32/12/124003[3] Yue Y Z, Hu Z Y, Guo J, et al. Ultrascaled InAlN/GaN HEMTs with fT of 400 GHz. IWN Tech Dig, 2012:558 http://stacks.iop.org/1347-4065/52/08JN14[4] Schuette M L, Andrew K, Song B, et al. Gate-recessed integrated E/D GaN HEMT technology with fT/fmax > 300 GHz. IEEE Electron Device Lett, 2013, 34(6):741 doi: 10.1109/LED.2013.2257657[5] Wang Chong, Zhang Jinfeng, Quan Si, et al. An enhancement-mode AlGaN/GaN HEMT with recessed-gate. Journal of Semiconductors, 2008, 29(9):1682 http://www.jos.ac.cn/bdtxbcn/ch/reader/view_abstract.aspx?flag=1&file_no=08031401&journal_id=bdtxbcn[6] Medjdoub F, Alomari M, Carlin J F, et al. Effect of fluoride plasma treatment on InAlN/GaN HEMTs. Electron Lett, 2008, 44(11):696 doi: 10.1049/el:20080864[7] Yasuhiro U, Tatsuo M, Ayanori I, et al. GaN monolithic inverter IC using normally-off gate injection transistors with planar isolation on Si substrate. IEDM Tech Dig, 2009:165 http://ieeexplore.ieee.org/xpl/abstractAuthors.jsp?reload=true&arnumber=5424397&openedRefinements%3D*%26filter%3DAND%28NOT%284283010803%29%29%26pageNumber%3D9%26rowsPerPage%3D100%26queryText%3Dmatsuo+and+nagasakimetadata[8] Gu Guodong, Cai Yong, Feng Zhihong, et al. Enhancement-mode InAlN/GaN MISHEMT with low gate leakage current. Journal of Semiconductors, 2012, 33(6):064004 doi: 10.1088/1674-4926/33/6/064004[9] Cai Y, Zhou Y, Chen K J, et al. High-performance enhancement-mode AlGaN/GaN HEMTs using fluoride-based plasma treatment. IEEE Electron Device Lett, 2005, 26(7):435 doi: 10.1109/LED.2005.851122[10] Chen G, Kumar V, Schwindt R S, et al. A low gate bias model extraction technique for AlGaN/GaN HEMTs. IEEE Trans Micro Theory Tech, 2006, 54(7):2949 doi: 10.1109/TMTT.2006.877047[11] Cai Y, Zhou Y G, Lau K M, et al. Control of threshold voltage of AlGaN/GaN HEMTs by fluoride-based plasma treatment:from depletion mode to enhancement model. IEEE Trans Electron Devices, 2006, 53(9):2207 doi: 10.1109/TED.2006.881054[12] Tang W, Xu K W, Wang P, et al. Abnormal increase of the resistivity of Au/NiCr/Ta multilayer after annealing. Acta Metall Sin, 2003, 39:172 http://www.ams.org.cn/CN/Y2003/V39/I2/172 -
Proportional views





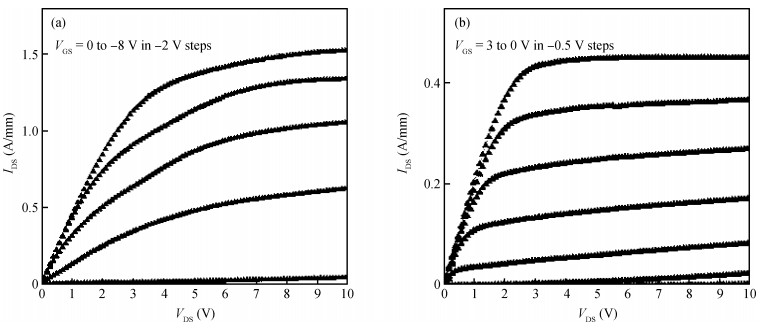
 DownLoad:
DownLoad: