| Citation: |
Jiangwei Cui, Qiwen Zheng, Xuefeng Yu, Zhongchao Cong, Hang Zhou, Qi Guo, Lin Wen, Ying Wei, Diyuan Ren. Hot-carrier effects on irradiated deep submicron NMOSFET[J]. Journal of Semiconductors, 2014, 35(7): 074004. doi: 10.1088/1674-4926/35/7/074004
****
J W Cui, Q W Zheng, X F Yu, Z C Cong, H Zhou, Q Guo, L Wen, Y Wei, D Y Ren. Hot-carrier effects on irradiated deep submicron NMOSFET[J]. J. Semicond., 2014, 35(7): 074004. doi: 10.1088/1674-4926/35/7/074004.
|
Hot-carrier effects on irradiated deep submicron NMOSFET
DOI: 10.1088/1674-4926/35/7/074004
More Information
-
Abstract
We investigate how γ exposure impacts the hot-carrier degradation in deep submicron NMOSFET with different technologies and device geometries for the first time. The results show that hot-carrier degradations on irradiated devices are greater than those without irradiation, especially for narrow channel device. The reason is attributed to charge traps in STI, which then induce different electric field and impact ionization rates during hot-carrier stress.-
Keywords:
- γ ray irradiation,
- deep submicron,
- hot-carrier effect
-
References
[1] Popp J D. Developing radiation hardened complex system on chip ASICs in commercial ultra deep submicron CMOS processes. IEEE Nuclear and Space Radiation Effects Conference Short Course Notebook, Denver, CO, Section Ⅱ, 2010[2] McBrayer J D, Fleetwood D M, Pastorek R A, et al. Correlation of hot-carrier and radiation effects in MOS transistors. IEEE Trans Nucl Sci, 1985, NS-32(6): 3935 http://ieeexplore.ieee.org/xpl/articleDetails.jsp?reload=true&arnumber=4334046&filter%3DAND%28p_IS_Number%3A4334025%29[3] McBrayer J D, Pastorek R A, Jones R V. A model describing hot-carrier and radiation effects in MOS transistors. IEEE Trans Nucl Sci, 1987, NS-34(6): 1647 http://ieeexplore.ieee.org/xpl/articleDetails.jsp?arnumber=4337530&contentType=Journals+%26+Magazines[4] Ren D, Yu X, Erkin, et al. Correlation between the damages of MOS capacitor induced by substrate hot-carrier ejection and total dose irradiation. Research & Progress of SSE, 2001, 21(1): 103[5] Yu Xuefeng, Ren Diyuan, Erken, et al. Correlations between MOS structures' responses to hot-carrier injection and total dose radiation. Journal of Semiconductors, 2005, 26(10): 1975[6] Silvestri M, Gerardin S, Paccagnella A, et al. Channel hot carrier stress on irradiated 130-nm NMOSFETs. IEEE Trans Nucl Sci, 2008, 55(4): 1960 doi: 10.1109/TNS.2008.2000771[7] Pagey M P. Hot-carrier reliability simulation in aggressively scaled MOS transistors. PhD Dissertation, Vanderbilt University, 2003[8] Cortés I, Roig J, Flores D, et al. Analysis of hot-carrier degradation in a SOI LDMOS transistor with a steep retrograde drift doping profile. Microelectron Reliab, 2005, 45: 493 doi: 10.1016/j.microrel.2004.08.005[9] Zhang Jincheng, Hao Yue, Liu Haibo. Hot-carrier damage of PMOSFET's identified by direct gate current measurement. Journal of Semiconductors, 2002, 23(1): 61 http://www.oalib.com/paper/1521615[10] Qian Qinsong, Liu Siyang, Sun Weifeng, et al. Research into charge pumping method technique for hot-carrier degradation measurement of LDMOS. Journal of Semiconductors, 2009, 30(10): 104005 doi: 10.1088/1674-4926/30/10/104005[11] Zheng Qiwen, Yu Xuefeng, Cui Jiangwei, et al. Degradation of the front and back channels in a deep submicron partially depleted SOI NMOSFET under off-state stress. Journal of Semiconductors, 2013, 34(7): 074008 doi: 10.1088/1674-4926/34/7/074008[12] Li E, Prasad S. Channel width dependence of NMOSFET hot carrier degradation. IEEE Trans Electron Devices, 2003, 50(6): 1545 doi: 10.1109/TED.2003.813342[13] Schwank J R, Shaneyfelt M R, Fleetwood D M, et al. Radiation effects in MOS oxides. IEEE Trans Nucl Sci, 2008, 55(4): 1833 doi: 10.1109/TNS.2008.2001040[14] Faccio F, Cervelli G. Radiation-induced edge effects in deep submicron CMOS transistors. IEEE Trans Nucl Sci, 2005, 52(6): 2413 doi: 10.1109/TNS.2005.860698[15] Hu Z, Liu Z, Shao H, et al. Simple method for extracting effective sheet charge density along STI sidewalls due to radiation. IEEE Trans Nucl Sci, 2011, 58(3): 1332 doi: 10.1109/TNS.2011.2142323 -
Proportional views





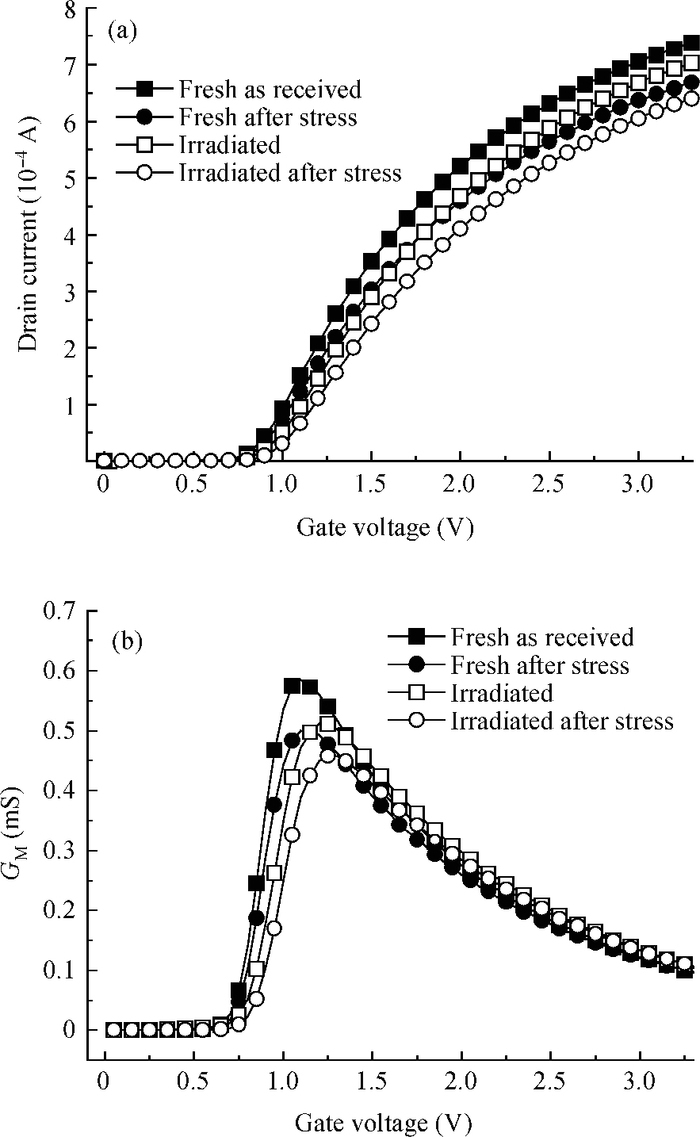
 DownLoad:
DownLoad: